1. MOS 电容
1.1. FET
FET 是一种具有增益的三端器件采用平行板电容器(如堆栈) 。电容器的一个平面充当源极和漏极之间的可切换导电沟道,另一个平面(栅极)通过电介质中的电场控制沟道中感应的电荷。
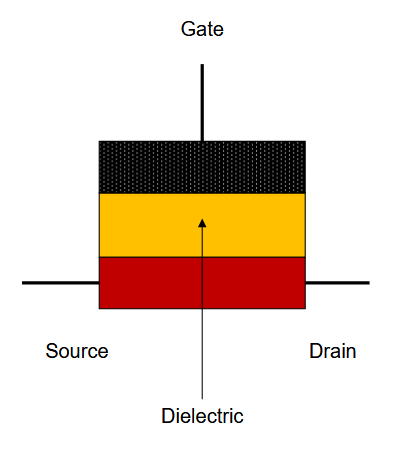
FET 可以分为 3 类,JFET(junction feild effect transistor)、MESFET(metal-semiconductor field effect transistor)以及 MISFET(metal insulator semiconductor filed effect transistor)。
MISFET 又分为 MOSFET(metal oxide semiconductor filed effect transistor)和 thin film transistor。我们主要关注 MOSFET。
1.2. MOSFET 结构
Transclude of MOSFET#结构
MOSFET 和 BJT 相比有什么优点?
- MOSFET 的制造更为简单;
- MOSFET 的结构更简单,因此也更容易集成;
- MOSFET 开光速度更快;
1.3. MOSFET 缩放
根据摩尔定律,MOSFET 的尺寸每 18 个月就会缩减为之前的 0.707 。这里的尺寸一般指最小特征尺寸。
特征尺寸
特征尺寸(也叫单位尺寸)一般用
表示,一般是指源漏之间的距离,由多晶硅的最小宽度来设定(最小线宽,可以理解为沟道长度?)。 指向原始笔记的链接
1.4. MOS 电容
MOS 电容是 MOSFET 分析中很重要的一部分。其结构如下,主要由栅极(金属或者重掺杂多晶硅)、
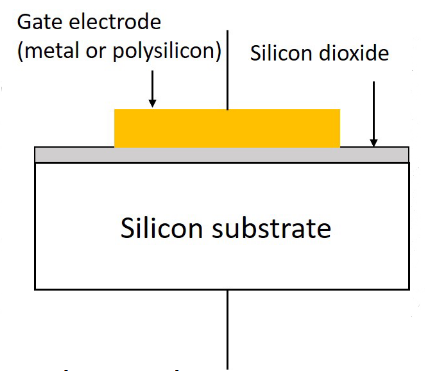
[! caution] p-MOSC 为 p-Si 衬底; n-MOSC 为 nSi 衬底
1.4.1. 能带结构
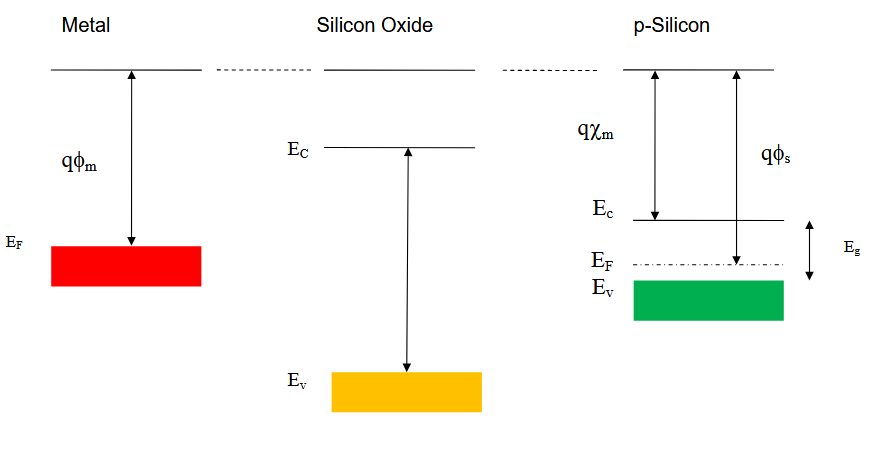
有一些基础定义
真空能级
真空能级
指向原始笔记的链接是指电子脱离晶格,称为自由电子时的能量。这个能级通常被用作一个参考点,以定义材料内部的其他能级,如费米能级、导带底和价带顶。在能级图中,真空能级通常位于最高位置,表示电子在无限远处的能级。
电子亲和能
在半导体中,电子亲和能
指向原始笔记的链接指的是将电子从导带底 移动到真空能级 所需要的能量。
功函数
在半导体中,功函数
指向原始笔记的链接指将电子从费米能级移动到真空能级所需要的能量。也就是电子逸出表面吸收的所需要的最小能量。如果电子具有的能量小于功函数,则无法从材料表面发射出去。
电离能
电离能是指将电子从价带顶移动到真空能级所需的能量。
指向原始笔记的链接
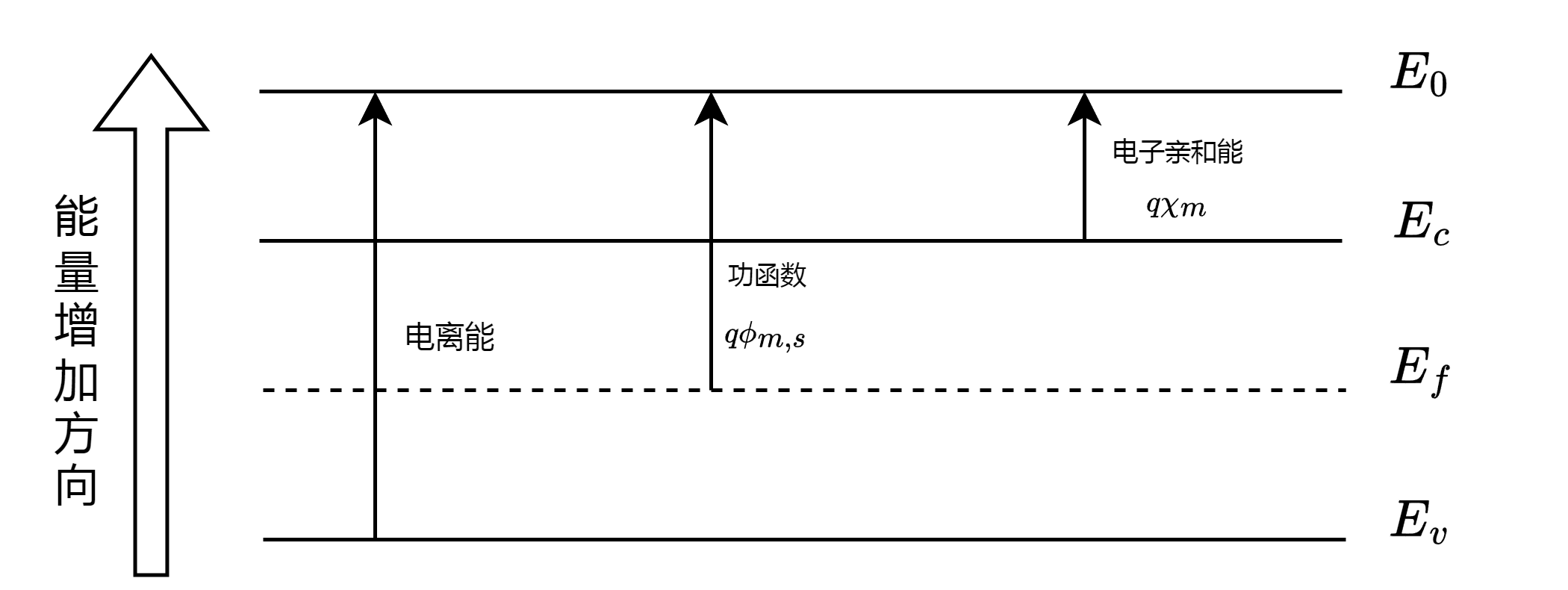
1.4.2. 偏置情况
根据栅极电压,MOS 电容能被偏置到以下四种平衡状态,
- 平带
- 累积
- 耗尽
- 反型 这里我们只关注 p-MOS 电容的耗尽和反型阶段。
1.4.2.1. 平带
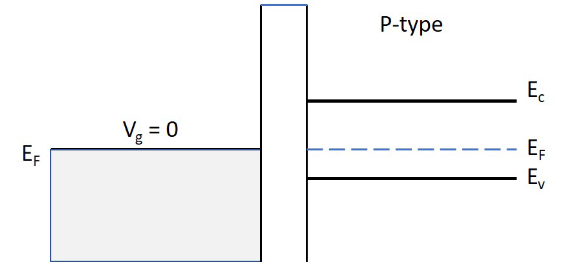 上面图是栅极、氧化层和 p 衬底的能带图。对于 MOS 电容而言,这是一种特殊情况,在硅内没有净电荷或者电场。并且只在特殊的栅电压下出现。
上面图是栅极、氧化层和 p 衬底的能带图。对于 MOS 电容而言,这是一种特殊情况,在硅内没有净电荷或者电场。并且只在特殊的栅电压下出现。
Note
硅和氧化物的能带都是平坦的。对于假设的
的情况,平带会发生在平带电压 (但是通常来说, 都不为 0)
1.4.2.2. 积累层形成
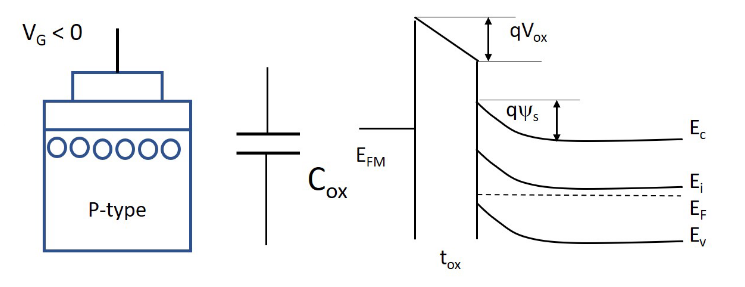 当对栅极施加负电压的时候,栅极的总电势会低于 p 衬底的电势,由此在氧化层中形成了一个从 p 衬底指向栅极的电场。电场的存在改变了衬底表面的电势分布,使得衬底表面附近的电势能增加,从而使得价带顶和导带底的能级上升。导带底的能级上升,使得表面附近的电子能态能量增加。价带顶的能级上升,使得表面附近的空穴能态能量降低。由于价带顶的能级上升,价带中的能态能量更接近费米能级(平衡状态时,
当对栅极施加负电压的时候,栅极的总电势会低于 p 衬底的电势,由此在氧化层中形成了一个从 p 衬底指向栅极的电场。电场的存在改变了衬底表面的电势分布,使得衬底表面附近的电势能增加,从而使得价带顶和导带底的能级上升。导带底的能级上升,使得表面附近的电子能态能量增加。价带顶的能级上升,使得表面附近的空穴能态能量降低。由于价带顶的能级上升,价带中的能态能量更接近费米能级(平衡状态时,
或者直观来看,栅极施加负电压,栅极电子累积导致衬底空穴累积,才能形成电容。
1.4.2.3. 耗尽层形成
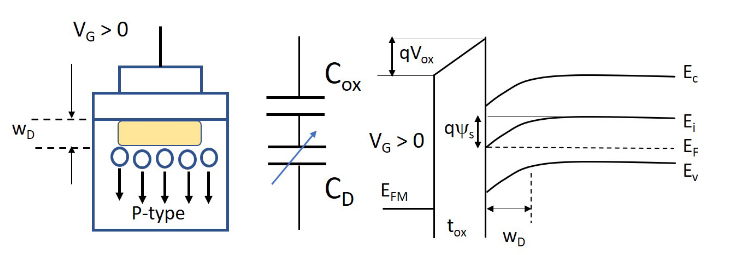
当对栅极施加正电压的时候,栅极的电势会高于衬底的电势,由此在氧化层中形成一个从栅极指向衬底的电势。电场的存在使得衬底表面电势能下降,价带顶和导带底能级下降。从而使得电子能态能量减少,空穴能态能量增加。由于导带底的能级下降,使得导带中能态能量更接近费米能级,从而使得电子在导带中出现概率增加,电子浓度上升。
可以看到,此时的电容由氧化层电容和耗尽层电容两个部分串联组成。
上面的能带图是一个特殊情况,即
1.4.2.4. 反型层形成
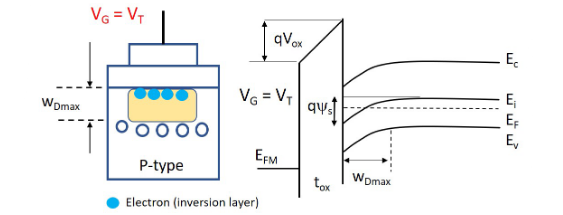
相对于硅衬底的正栅极偏压。金属中电子的能量相对于硅来说较低。在氧化硅中感应出电场。 Si 的能带向下弯曲; Si 表面附近的空穴浓度降低。 Si 表面耗尽了多数载流子,耗尽宽度为 WD。
此时有
反型又分为弱反型和强反型,
- 弱反型:一旦表面上的
与 重合(即 MOSFET 关闭),就会发生。 - 强反型:当表面的电子浓度等于 Si 本体中的空穴浓度时(⇒ MOSFET 导通),就会发生这种情况。
在强反转时,Si 中的负电荷由以下部分组成:
- 表面反转层中的电子(移动)
- 负受主掺杂剂固定电荷(静止)
由于反型层的静电屏蔽效应,耗尽层的宽度不再随栅极偏压而增加。此时耗尽层的最大宽度为
。
1.4.3. 硅的表面电势
1.4.3.1. 泊松方程
用于寻找半导体器件内的电势。根据高斯定律:
代入
对于笛卡尔坐标中的一维问题,这简化为:
一维形式的泊松方程
指向原始笔记的链接
为电势; 为电荷密度; 为介电常数。
1.4.3.2. 表面势求解
硅内的静电势通常(但不一定)使用本征势(或者叫本征费米势)
对于一维分析,Si 中的能带弯曲由下式给,
这里我们假设
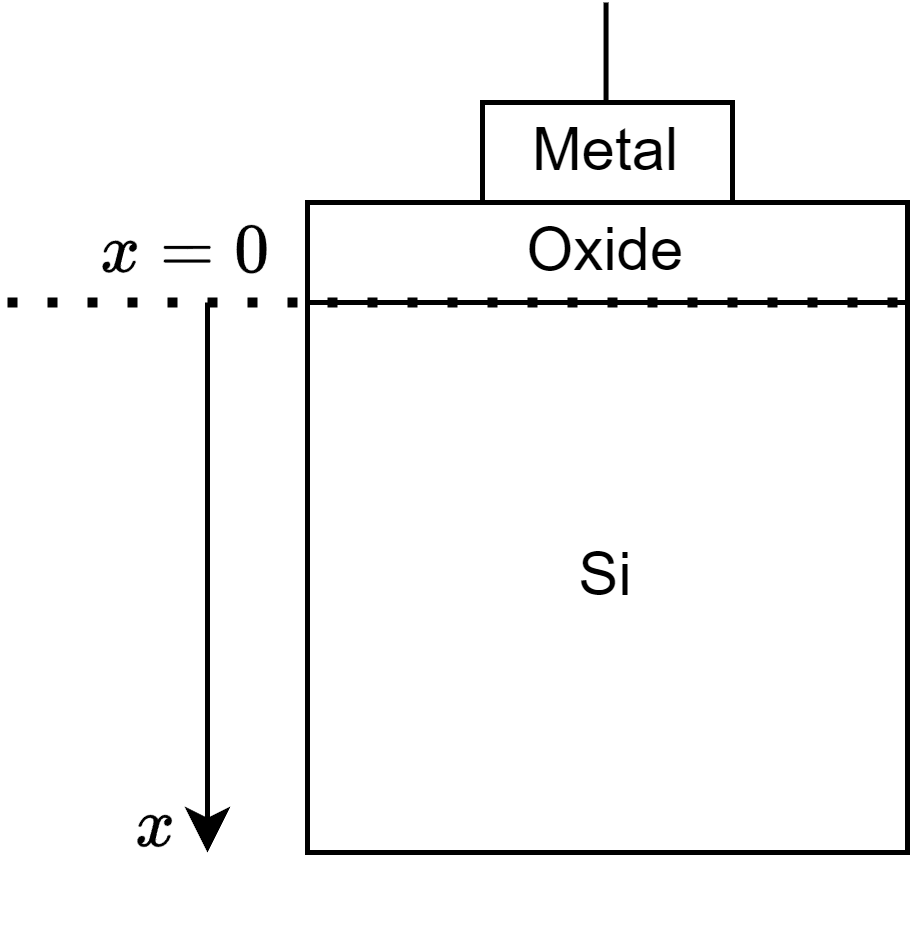
从下面这张图能更好地理解表面电势。在表面处的

1.4.3.3. 求解 p-MOSC 的泊松方程
电势
受以下边界条件影响:
- 在衬底内
(无穷远处) - 在硅表面
(表面势) 并且有 。
由于在衬底的无穷远出总电荷是中性的,我们有,
因为 p 衬底是掺杂的受主原子,因此我们用
同理也能给出,
[! question] 所以 x 处的空穴浓度和电子浓度就是由本征费米势和费米势之间的差值定义的吗?如果本征费米势高于费米势,也就是(准)费米能级高于本征费米能级的时候,就是电子浓度更高。 确实很符合直觉。
把以上内容全代入泊松方程中,
注意:右侧不再明确涉及 Nd。经过一些代数运算后,这个方程可以从 Si 的块体解析积分到任意点 x。
所以电场
 在
在
这个是一个很重要的结论。该方程体现了前面讨论的所有 MOS 偏置条件(即平带、累积、耗尽、反转)。方括号中的第一项是指 pMOSC 的正电荷,第二项是指电子。
1.4.4. 硅电荷
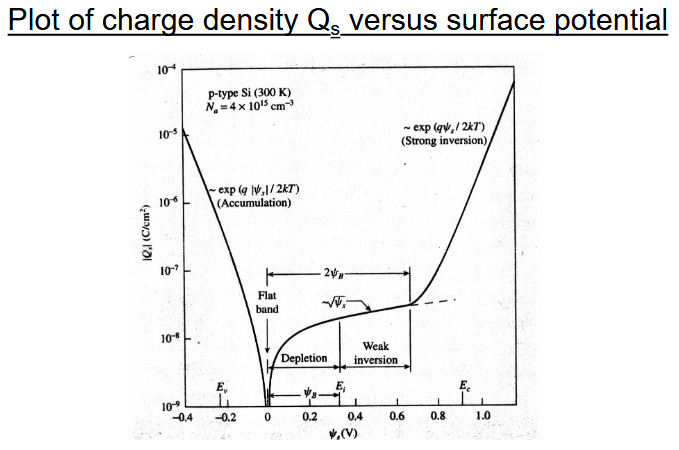 这是室温(300k)条件下 p 型硅的电荷密度和表面电势的关系。
这个图分为两个部分,电荷密度为 0 的地方为分界线。主要看“Accumulation”和“Strong inversion”这两个电荷密度增加非常快的区域。积累区一般被用于需要快速开启 mos 的地方;
这是室温(300k)条件下 p 型硅的电荷密度和表面电势的关系。
这个图分为两个部分,电荷密度为 0 的地方为分界线。主要看“Accumulation”和“Strong inversion”这两个电荷密度增加非常快的区域。积累区一般被用于需要快速开启 mos 的地方;
将上图和 MOS 电容的四个偏置情况连起来
- 对于平带,
,并且 ; - 对于累积,
(电子能量), 项占主导地位,Qs 随着 增加 - 对于耗尽,
, 项占主导地位,Qs 随着 增加 - 当
进一步增加时,指数项 最终成为主导并发生反型。 Qs 与 成正比。
1.4.4.1. 强反型
这种情况只能通过数值求解,因为必须包括耗尽电荷项和反转电荷项,
举例:
对于  可以发现,即使表面电势增加很小,但是硅电荷增加非常多。同时也可以发现,反型层其实非常薄,大部分电子都集中在
可以发现,即使表面电势增加很小,但是硅电荷增加非常多。同时也可以发现,反型层其实非常薄,大部分电子都集中在
如何找到电子浓度?
1.4.4.2. 强反型的通用标准
当表面电势达到某个值时,就会发生强反转的开始:
可以重写为,
由此
1.4.4.3. MOS 栅极电压方程
Si 表面电势
其中 Cox 是单位面积的氧化物电容。注:Vg 是氧化物上的电压降和 Si 中的能带弯曲之和,为简单起见,我们假设 Vfb = 0。实际上,Vfb 可能不为零。
1.4.5. MOS 小信号电容
总小信号 MOS 电容定义为,
我们可以对栅极电压方程对 |Qs| 进行微分并定义 Si 元件电容:
并按照串联电容来重写为,
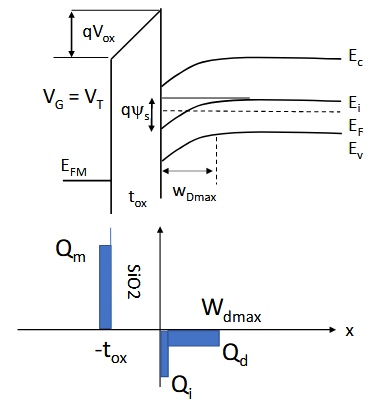 从下面这个电容-栅极电压曲线可以看出电容随着栅极的变化,值得注意的是,当进入强反型阶段的时候,电容值和频率开始相关。
从下面这个电容-栅极电压曲线可以看出电容随着栅极的变化,值得注意的是,当进入强反型阶段的时候,电容值和频率开始相关。
1.4.5.1. C-V 曲线测量方法
C-V 曲线主要还是需要实验来得到。主要步骤:
- 在 MOS 电容器上施加逐步增加的直流偏置。
- 叠加一个小交流信号(<100mV)
- 感测异相(无功)分量电流或者
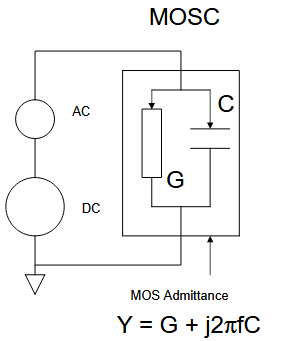
1.4.6. 电容-电压关系
2021 #EE6604期末/2022
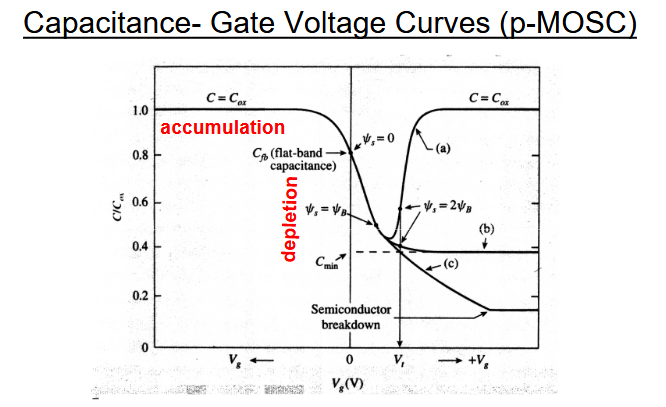
1.4.6.1. 电容-电压:积累
由泊松方程的解可知,在累加区:
对 Qs 对
MOS 电容为,
由于室温下为 2kT/q ~ 52mV,第二项很快变得可以忽略不计,随着 Vg 减小,MOS 电容 C 迅速接近 Cox。对于逐渐减小到接近
1.4.6.2. 电容-电压:耗尽
在这个区域,耗尽近似适用并且
其中 Cd 是耗尽区电容。总电容为,
电容随着该区域栅极偏压的增加而减小。
1.4.6.3. 电容-电压:反型低频(a)
电容取决于小信号电压的频率。对于准静态(低频)情况,一旦达到
1.4.6.4. 电容-电压:反型高频(b)
如果施加的交流信号的频率太高,反型电荷(少数载流子)将无法跟随信号变化,只有耗尽电荷(多数载流子)可以响应。
如果其频率低于少数载流子响应时间的倒数,则反转电荷只能跟随交流信号。该响应时间与少数载流子寿命成正比,通常为 0.1-10 秒,具体取决于晶圆质量(缺陷)。通常,对于高于 ~100Hz 的频率,只能观察到高频电容。
1.4.6.5. MOS 电容等效电路
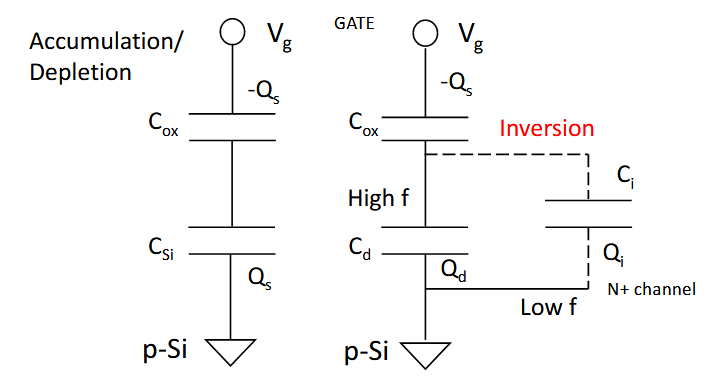
1.4.6.6. 深耗尽(c)
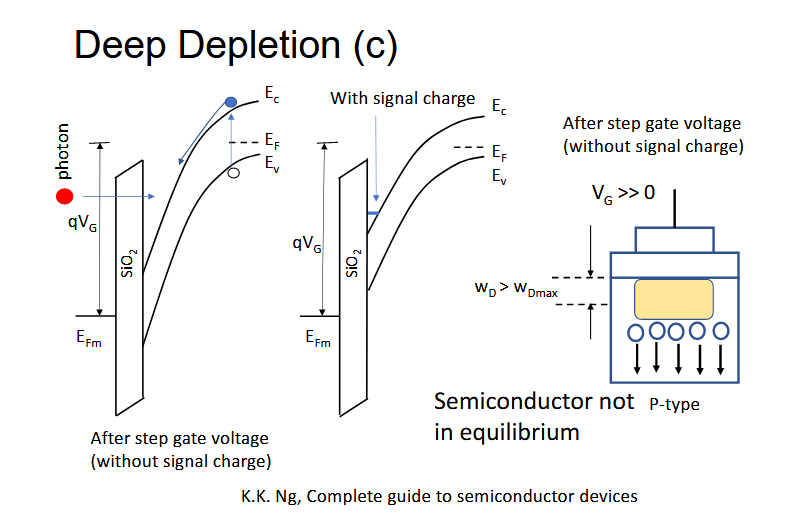
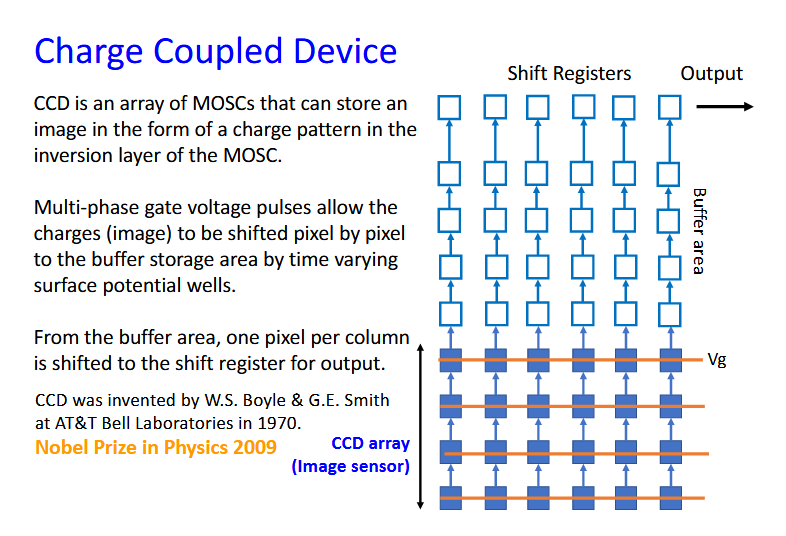
2. 氧化物和界面电荷
实际的 MOS 的 CV 特性和理想情况不太一样。主要有以下的影响因素
- 移动离子电荷,
- 氧化物俘获电荷,
- 固定氧化物电荷,
- 界面俘获电荷,
2.1. 二氧化硅中的电荷
下面这张图展示了氧化层和基底之间的接触和刚刚提到的四种不同的电荷的位置。
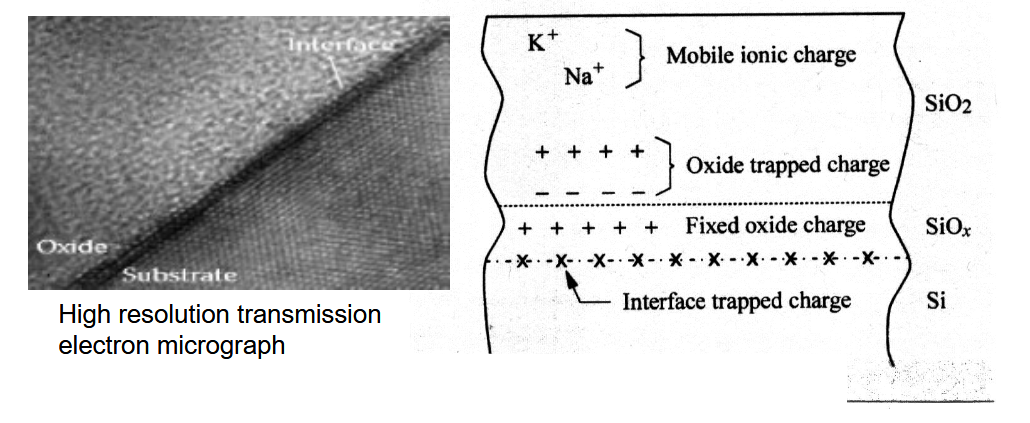
2.2. 界面俘获电荷
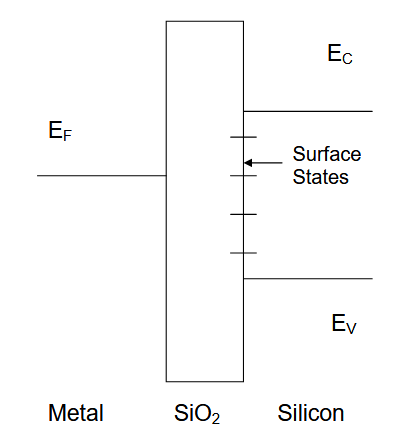
由于硅表面的周期性终止(硅原子的化学键不一定能连接形成的悬空键)而形成局域电子态。表面态位于 Si-SiO2 界面,能量位于 Si 带隙中。
表面态的存在使得电子和空穴能够被捕获,并由此
- 减少了传导电流
- 降低了载流子的迁移率
2.2.1. 如何控制表面态
- 表面态密度很大程度上取决于晶向 (100) < (110) < (111)。因此,Si (100) 晶圆是 CMOS 制造的首选。
- 金属化后退火:在含氢(或氘,D2,氢的同位素,原子核中有一个中子)的环境中于
2.3. 固定氧化物电荷
由氧化或氧化后退火过程中引入的过量硅产生(退火时产生了缺陷)。位于非常靠近
2.4. 移动离子电荷
移动离子电荷是晶圆加工过程中 Na+ 或 K+ 污染造成的。这也说明了为什么会出现在氧化物的最上层。
当施加电场和高温时,Na+ 和 K+ 离子很容易在
2.5. 氧化物俘获电荷
在
通过热退火相对容易地去除局部态。
2.6. 缺陷电荷对 MOS 电容器的影响
缺陷电荷可能导致 MOS 电容器的 C-V 曲线相对于理论(理想)C-V 曲线被拉长或偏移。
3. MOSFET 历史发展
历史部分跳过。介绍了 1960 发明的 PMOS。主要遇到的困难就是前面提到的表面态导致的问题。后面才使用退火来解决这个问题。
3.1. 几种 NMOS 器件
3.1.1. 平面 NMOS
在 1960-2010 都使用这个类型的 NMOS
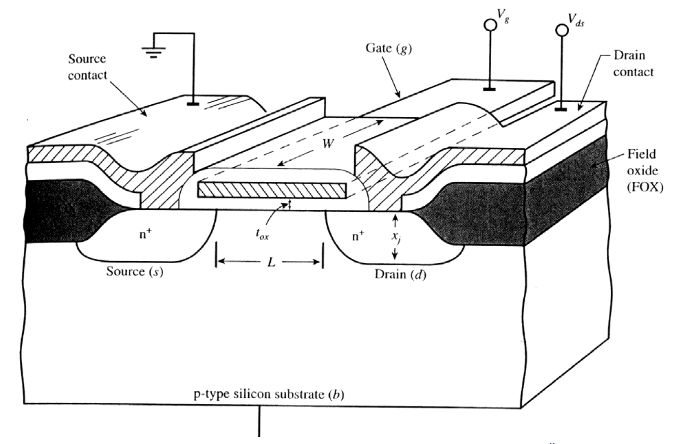
用反型层的类型给 MOSFET 来命名,反型层为 N 型,那就是 NMOS。能理解上图各个结构的作用即可。
[! info] NMOS 结构
然后还讲了 《Chapter 4 CMOS 工艺增强》笔记的内容。就是在平面 NMOS 遇到 scale-down 的问题时,提出的解决方案。
然后简单讲了理想 NMOS 的工作模式的开关两种状态。
4. 长沟道 MOSFET
将使用两种近似来推导长沟道 MOSFET 的电流电压特性以及紧凑模型:
- 渐进沟道近似 (GCA)
- 电荷表近似 (CSA) 最后得到电流-电压表达式来描述 MOSFET 器件的“导通状态”。
4.1. 漏电流模型
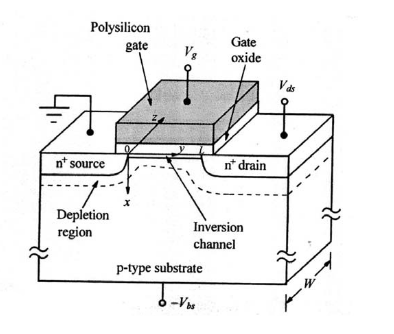
主要需要注意 x 轴和 y 轴的方向。x 轴垂直与
端电压: Vds:漏极电压(相对于源极) Vg:栅极电压 V (y):沿沟道 y 点的电压(相对于源极)
4.2. 渐进沟道近似
渐进沟道近似
沿通道(y 方向)的电场变化远小于垂直于通道(x 方向)的相应场变化。
[! attention] 使用 GCA 会将泊松方程从二维简化为只是一维并简化了分析。适用于除夹断点及其以外的大部分通道。
Jn (x, y) 包括漂移电流和扩散电流,因为 V (y) 已隐式假设为电子准费米势。
是反型层的厚度。这里假设了场变化很小,于是 当作常数 将
定义为栅极下沿通道距离 y 处每单位面积的电荷(将通道纵向切分,从上往下积分): 指向原始笔记的链接
4.3. 电荷层近似
电荷层近似
反转电荷恰好位于硅表面并形成厚度为零的电荷层。反型层上没有电势降。
注:使用 CSA,可以找到漏极电流的解析解。
电荷层(charge sheet)下方是耗尽区。由于强反转的开始,该区域的表面电势(或能带弯曲)为
。 使用耗尽近似,体耗尽电荷密度为,
硅中的总电荷为,
反型电荷密度是
和 之差: 通过将其代入
并积分,我们得到, 这是长沟道 MOSFET 的基本电流电压特性。
指向原始笔记的链接
4.4. MOSFET 导通时的两个区域
区域的划分是按照
- 线性区:电流 Ids 随 Vds 近似线性增加
- 饱和区:电流 Ids 变得与 Vds 无关。

4.4.1. 线性区
栅极电压高于阈值电压;反型层从源极延伸到漏极。
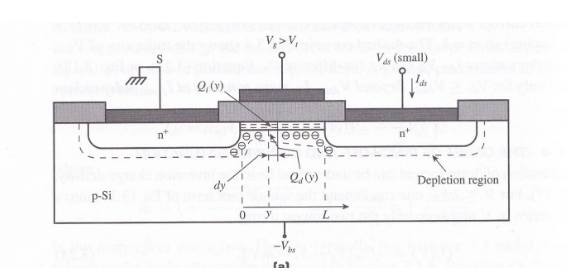 漏极电流,
漏极电流,
阈值电压
晶体管的行为类似于具有薄层电阻率的电阻器:
该薄层电阻率由栅极电压
4.4.1.1. 阈值电压的实验测定
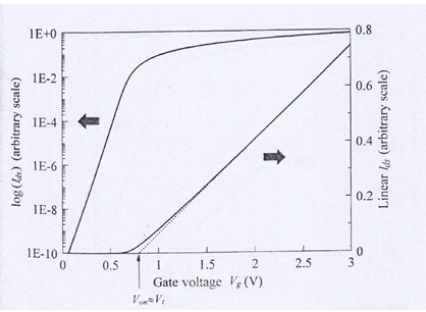 绘制小 Vds 情况下的 Ids 与 Vg 的关系图。将 Ids (Vg) 曲线的线性部分外推到 Vg 轴并找到 Vg 截距。注意:这个线性外推的阈值电压并不完全是 Vt,通常指定为
绘制小 Vds 情况下的 Ids 与 Vg 的关系图。将 Ids (Vg) 曲线的线性部分外推到 Vg 轴并找到 Vg 截距。注意:这个线性外推的阈值电压并不完全是 Vt,通常指定为
4.4.2. 饱和区
m 通常在 1.1-1.4 范围内。
最大电流出现在
此时有电流,
4.4.3. 夹断
4.5. 亚阈值特性
当 Vg 仅略低于 Vt (~10-1V) 时,漏极电流不为零。这个电流即为亚阈值电流。这是因为硅表面处于弱反转状态,少数载流子仍然存在。
MOSFET 的亚阈值电流对于数字 CMOS 应用极为重要,因为无论 CMOS 逻辑门的哪种输出状态,一个极性的一半 MOSFET 都会导通,而相反极性的其他 MOSFET 则截止。亚阈值传导限制了它们的关断行为并增加了待机功耗。 (重大问题!)
4.5.1. 亚阈值电流机理
亚阈值电流产生的本质是在 MOSFET 处于弱反型时,电子能通过热发射越过势垒。
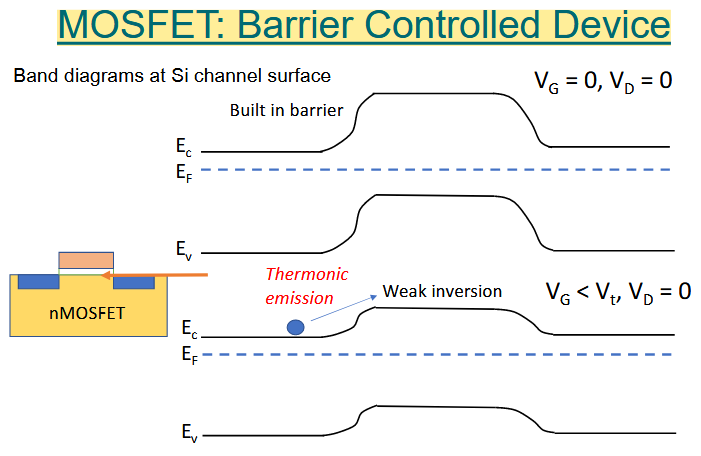 在亚阈值区域,扩散电流和漂移电流都很重要。这与漂移电流是主要电流分量的饱和区不同。分析亚阈值电流并不容易,我们仅限于低漏极偏置的情况。将反型电荷 Qi 代入漏极电流方程并积分可得出:
在亚阈值区域,扩散电流和漂移电流都很重要。这与漂移电流是主要电流分量的饱和区不同。分析亚阈值电流并不容易,我们仅限于低漏极偏置的情况。将反型电荷 Qi 代入漏极电流方程并积分可得出:
[! note] 注:亚阈值电流取决于 Vg、Vds 和体效应系数。然而,对于大于几个 kTs 的 Vds,亚阈值电流主要由 Vg 控制。
4.5.2. 亚阈值斜率
2022 #EE6604期末/2023
亚阈值摆幅用来描述 mosfet 在亚阈值区域的电流-电压特性。其定义为在亚阈值区域内,栅极变化 1V,漏极电流的对数值变化量。可以用来衡量多快能将
区分相对于 Vg 的亚阈值摆幅计算式
指向原始笔记的链接
[! note] 注意:由于导出 Ids 时采用了近似值,上面给出的 S 表达式低估了实际亚阈值斜率 5-10%
[! note] 亚阈值斜率 S 主要由热载流子的玻尔兹曼分布决定(见亚阈值电流的机理),而这种分布与MOSFET的物理尺寸无关。因此,即使MOSFET的尺寸缩小,热载流子的分布特性仍然保持不变
对于 VLSI 应用,S 应较小,以获得快速器件关断。然而,这并不容易实现,因为 S 主要取决于温度 T。可以利用衬底掺杂剂浓度 Na 和栅极氧化物厚度通过体效应系数将 S 调整到有限的程度。
4.5.2.1. 亚阈值斜率的重要性
亚阈值斜率对于低功率微电子学尤其重要。通常,降低电源电压以节省待机功率和开关功率。然而,由于 S 的有限值和可扩展性有限,电源电压不能任意小。降低 Vcc 过多可能会导致逻辑“0”处出现显着漏电流,因为逻辑低电平与 Vt 太“接近”。
5. 亚微米 MOSFET
5.1. 二次效应
5.1.1. 亚微米 MOSFET 二次效应的来源
- 一维模型中的假设被打破,或者等效地,二维效应的出现、
- 没有严格遵循缩放 MOS 器件的规则
5.1.2. 短沟道效应
2021 #EE6604期末/2022 #EE6604期末/2023
短沟道效应是指随着沟道长度减小,MOSFET 阈值电压 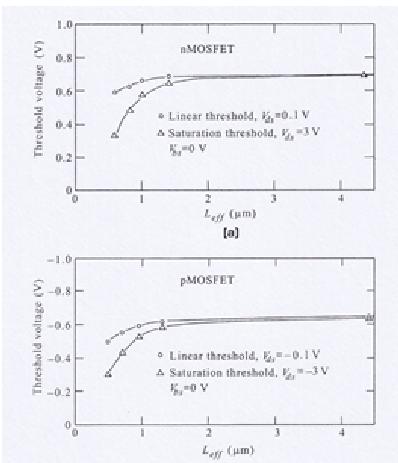 SCE 的后果:
SCE 的后果:
- 可能导致器件漏电流和功耗增加。
- 芯片上的最小几何器件必须根据 SCE 进行设计。
短沟道 MOSFET 中的亚阈值电流,可以看出当 L 减小到 0.2 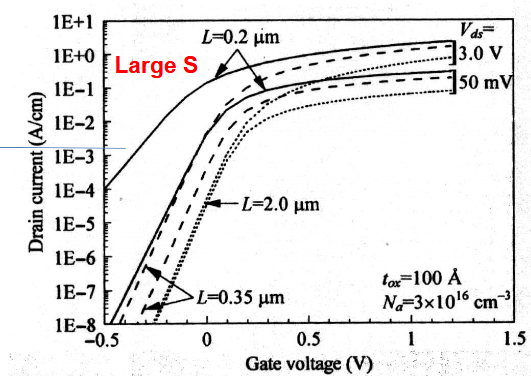
5.1.2.1. 短沟道效应的物理原因
对于长沟道器件,模拟2μm 器件主要沿 y 轴的等势(平行于 Si-SiO2 界面)。电场仅在 x 方向上变化。 y 方向的变化最小。*一维场模式。
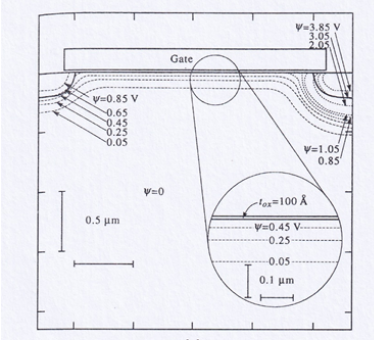 这里可以看出,沿着沟道的电子电势基本是和沟道长度相当且平稳的(仅仅在接近源端和漏端处呈现二维电场)。
这里可以看出,沿着沟道的电子电势基本是和沟道长度相当且平稳的(仅仅在接近源端和漏端处呈现二维电场)。
对于短沟道器件,对于相同的 Vg 和 Vds,等电位线更呈曲线状。电场是二维的。 Si 表面的能带弯曲更大,耗尽区更宽。器件具有较低的阈值电压。
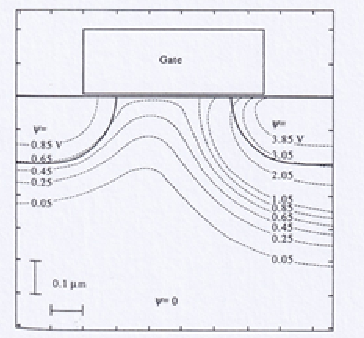 二维场图案是由于源极和漏极靠近而产生的。每个形成一个 p-n 结并具有相关的耗尽区。对于长沟道情况,这些耗尽区相距足够远,不会影响器件中的场图案。对于短沟道情况,源极-漏极的间隔与 MOS 耗尽宽度相当,因此场图案受源极漏极电压的强烈影响。
二维场图案是由于源极和漏极靠近而产生的。每个形成一个 p-n 结并具有相关的耗尽区。对于长沟道情况,这些耗尽区相距足够远,不会影响器件中的场图案。对于短沟道情况,源极-漏极的间隔与 MOS 耗尽宽度相当,因此场图案受源极漏极电压的强烈影响。
5.1.2.2. SCE 导致的阈值电压下降
用来解释这个现象的主要有两个模型:
- 电荷分享模型
- 漏极诱导势垒降低(DIBL) 我们主要看第二个模型。
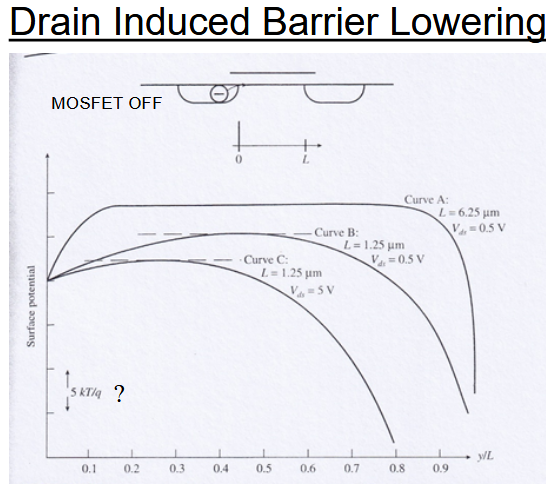 该图显示了表面电势(对于电子)作为归一化距离 y/L 的函数。在源极 (y/L=0) 处,当器件关闭时,表面势垒可防止电子进入沟道区域。对于长沟道情况(曲线 A),大部分沟道上的势垒是平坦且均匀的。对于短沟道情况(曲线 B、C),势垒较低且更圆。如果漏极偏压增加,势垒会进一步降低 (DIBL)。降低的势垒增加了电子进入通道的可能性并导致阈值电压降低。
该图显示了表面电势(对于电子)作为归一化距离 y/L 的函数。在源极 (y/L=0) 处,当器件关闭时,表面势垒可防止电子进入沟道区域。对于长沟道情况(曲线 A),大部分沟道上的势垒是平坦且均匀的。对于短沟道情况(曲线 B、C),势垒较低且更圆。如果漏极偏压增加,势垒会进一步降低 (DIBL)。降低的势垒增加了电子进入通道的可能性并导致阈值电压降低。
具有均匀掺杂密度的 nMOSFET 耗尽区的电场由下式给出:
注:
模拟横向场与耗尽区距离 y 的关系
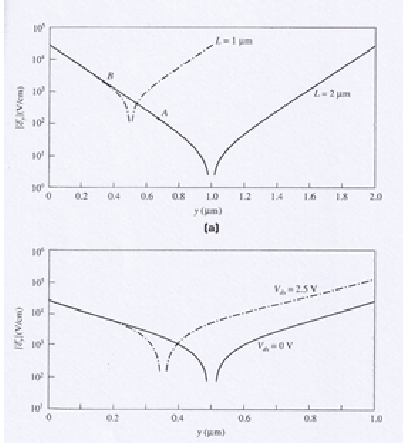 注:对于 (a),横向场随距离呈指数减小。这种指数衰减的特征长度不随沟道长度而改变。因此,短沟道器件中间的横向场强于长沟道器件。施加漏极偏压将零场点移向源极。零场点对应于 DIBL 中的潜在最大值点。
注:对于 (a),横向场随距离呈指数减小。这种指数衰减的特征长度不随沟道长度而改变。因此,短沟道器件中间的横向场强于长沟道器件。施加漏极偏压将零场点移向源极。零场点对应于 DIBL 中的潜在最大值点。
5.2. 解决方案
5.2.1. 源极漏极扩展
2021 #EE6604期末/2023
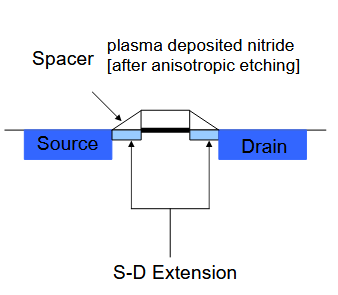
浅结插入源极-漏极和亚微米器件通道之间。自对准离子注入形成 S-D 延伸(低剂量)。沉积隔离介质 (SiN),然后进行第二次高剂量自对准注入。保持源极-漏极从通道“凹进”。权衡是寄生源漏串联电阻的净增加。
5.2.1.1. 源漏串联电阻
寄生电阻与源极和漏极区域以及欧姆接触的有限薄层电阻率相关。这种外在效应在长沟道器件中并不重要,因为长沟道器件的沟道电阻相当大,可以忽略不计。然而,沟道电阻与亚微米器件中的源极漏极电阻相当。因此,这种外在效应现在很重要。
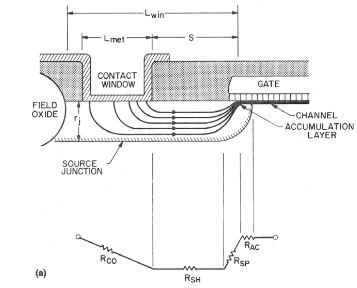
寄生源极漏极电阻可分为四个部分:
- Rac:积累层电阻
- Rsp:扩散电阻
- Rsh:薄层电阻
- Rco:接触电阻 由于栅极驱动的减少,源极侧电阻尤其不受欢迎。
累积层电阻栅极边缘通常与源极和漏极重叠。在栅极-源极(或-漏极)重叠区域,载流子被限制在具有电阻 Rac 的累积层中。
扩散电阻这是与注入电流从薄累积层扩散到源极或漏极相关的电阻分量。对于均匀掺杂的源极-漏极,
薄层电阻这是源极-漏极扩散区域的电阻,可以简单地由下式给出,
其中 S 是栅极边缘和金属接触边缘之间的间距,
接触电阻由下式给出:
其中
5.2.2. 自对准硅化物触点
在先进的 CMOS 器件中,通过使用自对准硅化物(self-aligned silicides or salicides)可以最大限度地减少
Rsh 仅限于间隔物下方的非硅化物区域。 Rco 减小是因为接触窗的宽度 lc 是硅化物扩散区域的宽度。
5.2.3. SOI
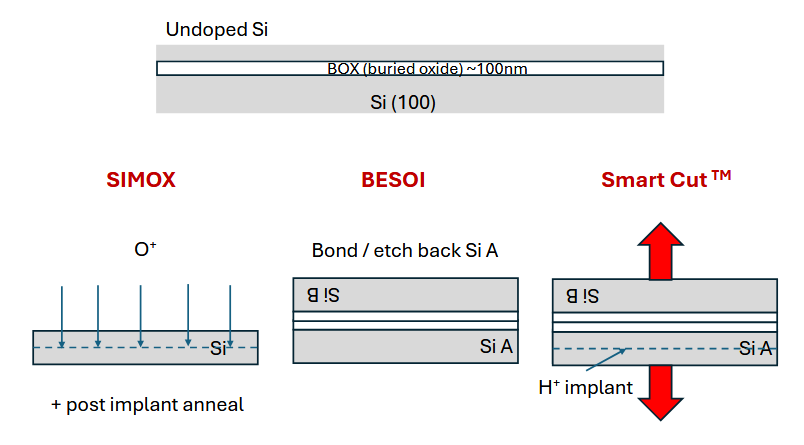
5.2.4. 双栅极 n-MOSFET
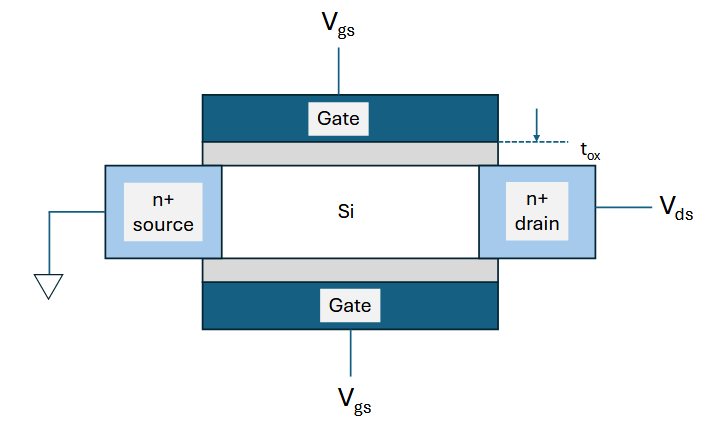
5.2.5. 多栅极 MOSFET