光刻是将设计好的图案转移到晶圆上的一种光学方法。设计通常使用 CAD 工具来完成。
光刻工艺类型
- 光刻 (SUSS MA6)
- 纳米压印光刻工艺 (EVG 520)
- 电子束光刻 (Raith EBPG 5200)
光刻工艺/流程的步骤
- 使用 CAD 工具进行设备/电路设计
- 掩膜制造
- 光刻曝光系统 (紫外光)
- 光敏薄膜 (光刻胶)
- 晶圆与掩膜对齐
- 光刻胶曝光
- 图案显影
- 曝光后处理 (金属化、蚀刻) 之后的剥离
- 工艺后清洗 (灰化)
光刻的工艺过程.excalidraw
⚠ Switch to EXCALIDRAW VIEW in the MORE OPTIONS menu of this document. ⚠
Excalidraw Data
Text Elements
曝光
图形转移
指向原始笔记的链接
光刻工具
- MJB4 (SUSS)
- MA6 (SUSS)
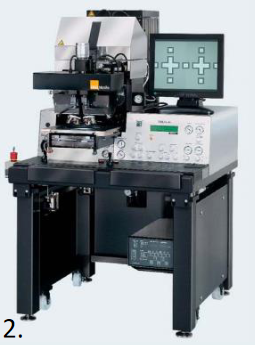
- EUV (ASML)
常见问题以及解决方法
驻波 Standing Wave
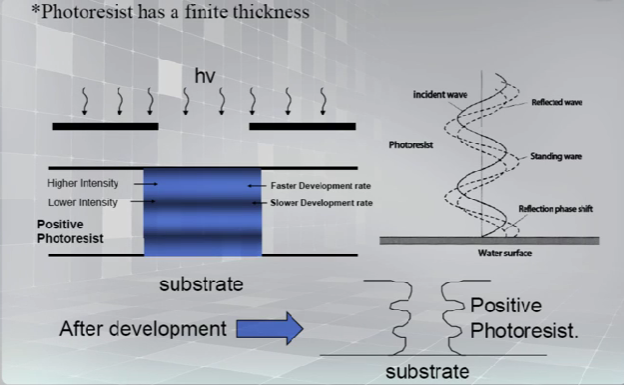
入射光和反射光相互作用形成驻波,使得在不同位置的光的强度不同,从而在光刻胶的侧面形成波浪状的纹路,影响结构尺寸。
解决方案
- 在光刻胶中加入吸收性更强的成分,减少反射;
- 使用多层光刻胶,使得界面反射更弱;
- 在硅片表面涂抹一层防止反射的涂层 BARC(bottom anti-reflection coating)(最为常用)
多层对准 Overlay
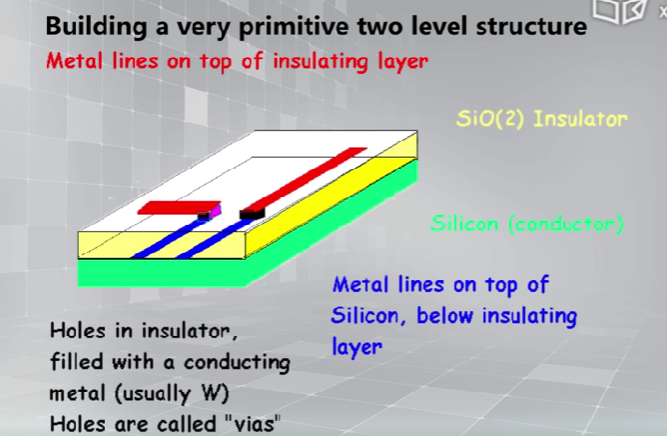
在使用光刻工艺的过程中,我们往往会需要构造多层,如上图所示。上图中蓝色为一层,紫色为一层,红色为一层。
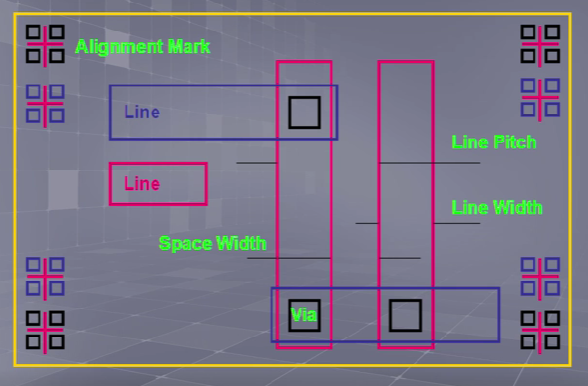
在每一层,我们都会使用标记来将它对准,第二、三层则是对准第一层的标记(上图的四角的黑色和蓝色方框)
Thermal run-in/run-out error
由于在晶圆和掩模具有不同的热膨胀系数,而在光刻的时候,温度可能发生变化,使得光刻图样变形。
Thermal run-in(out) error
指向原始笔记的链接
为 run-out error; 为晶圆半径; 为掩模和晶圆温度的变化量; 为掩模和晶圆的热膨胀系数。
Translation Error
掩模相对于晶圆向着某个方向偏移。
Rotation Error
掩模相对于晶圆发生了旋转。