使衬底在氧化气体环境中氧化。
氧化设备
常规炉式氧化设备


RTP 设备

加热温度高,速度快,可以减少热预算
热氧化过程
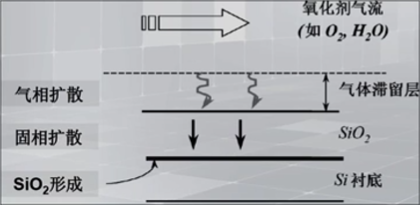
应注意的问题
杂质
Na、K 等金属离子在 SiO2 中是快扩散杂质,将在 SiO2 中起移动电荷作用,引起 MOS 器件阈值电压漂移。因此要严格栅氧化前的 Si 片清洗和氧化环境的污染控制;氧化气氛中通少量 HCI 气氛是控制金属离子沾污的一个办法;
界面态的控制
Si/SiO2 界面的缺陷将成为 MOS 器件栅下的界面态,也会引起 MOS 器件阈值电压漂移。需要优化氧化前的 Si 片表面处理,优化氧化工艺,尽量减少 Si/
硼穿透的问题
后续的加温过程中可能引起多晶硅栅中的 B 参杂穿透 SiO2 层进入沟道(B 在 SiO2 中是快扩散杂质)从而改变沟道内的杂质分布。
应对的方法:
提高
短沟道效应
随着栅长的缩短,
MOS 的栅控能力与单位面积下的栅电容