1. 清洁技术 Cleaning Technology
1.1. 晶圆加工需要清洁✨
不需要的杂质的重要性随着设备几何形状的缩小而增加。 75% 的产量损失是由于颗粒引起的缺陷(最小特征尺寸的 1/2)。
主要的检测手段有
- LLS: 局部光散射 localized light scatters(使用激光检测和计数颗粒);
- GOI: 栅极氧化完整性gate oxide integrity;
通过电气测量 DRAM 和逻辑芯片的要求不同,因为 DRAM 芯片上的栅极绝缘体面积更大。
清洗通常在所有扩散步骤和薄膜沉积步骤之前进行,并且在所有 RIE 或等离子体蚀刻步骤和等离子剥离工艺后进行。

主要就是氧化、光刻胶剥离、多晶硅沉积、离子注入等等。
1.2. 污染类型
- 颗粒
- 金属杂质
- 有机污染
- 原生氧化物
- 静电放电
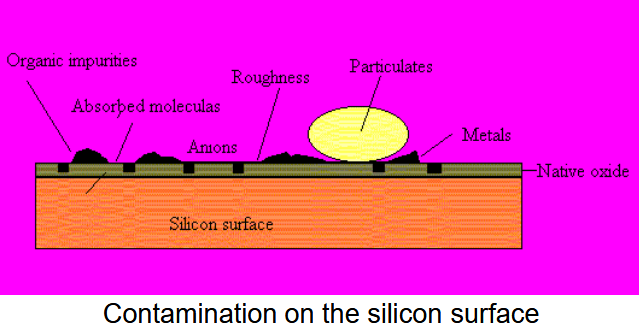
1.2.1. 颗粒
颗粒的沉积的根本原因是吸引力大于排斥力,
- 吸引力:
- 范德华力 van der Waals forces(短程力);
- 静电(长程力);
- 排斥力:
- 静电;
- 空间位阻力Steric forces
1.2.1.1. 表面电荷与表面电性
表面电荷的形成
- H+ 与 OH‐ 离子的吸附 (氧化物);
- 正负离子的选择性吸附 (疏水材料);
- 表面基团的电离 (如尼龙等聚合物);
- 基质结构中因反离子释放而暴露的固定电荷;
1.2.2. 金属杂质
| 重金属 Heavy Metals | 碱金属 Alkali Metals |
|---|---|
| Fe | Na |
| Cu | K |
| Al | Li |
| Cr | |
| W | |
| Ti |
1.2.3. 接触点上的原生氧化物
原生氧化物覆盖在接触孔的底部, 导致钨与掺杂硅区之间的电接触不良。
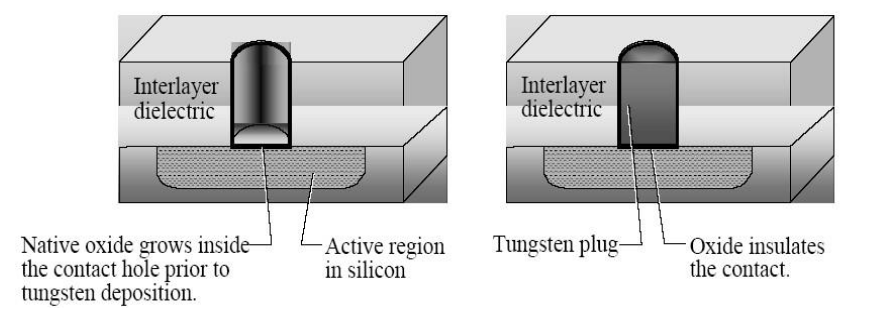
1.3. 湿法清洗工艺
现代集成电路工厂采用三层防护措施来控制有害杂质:
- 洁净工厂
- 晶圆清洗
- 吸杂工艺 Gettering
1.3.1. 洁净室
工厂环境通过以下方式清洁:
- HEPA 过滤器和空气再循环系统。
- 工人的 “ 兔子服 ”。
- 化学品与气体的过滤。
- 制造协议。
HEPA: High Efficiency Particulate Air,由超细玻璃纤维 ( <1微米直径) 制成的薄多孔片组成的。HEPA 过滤器能以 99.97% 的效率去除空气中的颗粒物。室内空气以 50 厘米 / 秒的速度强制通过过滤器。大颗粒被截留, 小颗粒因静电力附着于纤维上。排出的空气通常优于 1 级。
这里的 1 级指的是洁净室等级。
| 等级\每立方英尺空气中颗粒平均数量\颗粒直径( | 0.1 | 0.3 | 0.5 | 5.0 |
|---|---|---|---|---|
| 1 | 35 | 3 | 1 | |
| 10 | 350 | 30 | 10 | |
| 100 | 300 | 100 | ||
| 1000 | 1000 | 7 | ||
| 10000 | 10000 | 70 | ||
| 100000 | 100000 | 700 |
1.3.2. 现代晶圆清洗 ✨
清洗过程包括去除晶圆表面的颗粒、有机物和金属。在清洗过程中,
- 颗粒物主要通过超声波振荡被去除。
- 有机物 (光刻胶) 在
等离子体或 (食人鱼溶液 Piranha) 中被去除。 - “RCA 清洗 ” 用于去除金属和任何残留的有机物。
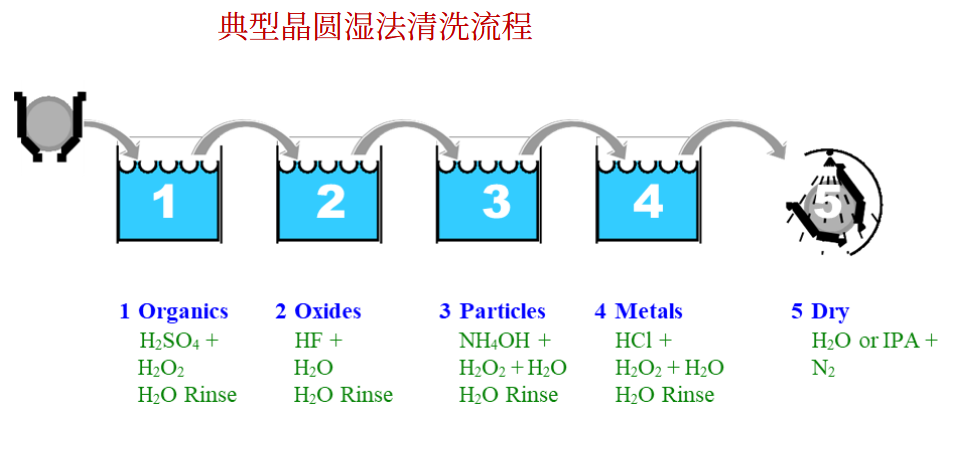
1.3.2.1. 化学品清洗 ✨
典型的晶圆清洗顺序是:有机物
1.3.2.1.1. 用于湿洗有机物的化学品——强氧化
食人鱼溶液或 SPM (硫酸-过氧化氢混合物) 。
- 主要构成为硫酸 / 过氧化氢 / 去离子水 ( SPM,
) - 温度范围 110-130°C
不同比例的
硫酸的缺点:
- 难以从表面清除;
- 用于冲洗的水通常非常热;
- 表面残留的硫含量非常高
- 通过短暂氢氟酸浸泡即可去除
1.3.2.1.2. 用于湿洗氧化物的化学品——刻蚀
氢氟酸或稀释氢氟酸 (
1.3.2.1.3. 用于湿洗颗粒的化学品——底切、静电排斥
APM (SC-1) ,
APM 将裸露硅氧化生成原生 (化学) 氧化层,以较低速率 ( ~1Å/ 分钟) 轻微蚀刻氧化层并可蚀刻硅,轻微蚀刻形成底切(减小颗粒与表面的接触), 从而去除表面颗粒。同时可清除有机及金属污染物。
问题:
- 也可能导致表面粗糙化
- 氧化剂的存在至关重要,若缺失, 溶液会腐蚀硅。
[! note] APM 的工作机制
- 氧化抬升颗粒,再刻蚀轻微溶解氧化层;
- 通过
使得表面形成负电,从而对颗粒静电排斥。
1.3.2.1.4. 用于湿洗金属的化学品
HPM ( SC-2 ) ,盐酸 / 过氧化氢 / 去离子水 ( HPM,
1.3.2.1.5. 去离子水
超纯水 ( UPW )。通常称为去离子水 ( DI 水)。晶圆制造中用量最大的化学品, 每片 8 英寸 CMOS 晶圆消耗 > 6000 加仑。用于稀释化学品及化学清洗后的溶液漂洗。在规定时间内多次漂洗, 直至溶液达到高电阻率。去离子水需现场制备, 以满足现代微纳制造对水质和纯度的严苛要求。每生产 1 加仑去离子水, 可能需消耗 4‐6 加仑城市原水。为维持所需品质与纯度, 去离子水必须持续循环处理。
1.3.2.1.6. 化学品总结
| 名称 | 材料 | 去除对象 | 缺点 |
|---|---|---|---|
| SPM | 有机物 | 氧化硅底;硫酸难去除;硫残留 | |
| 氧化物 | BHF 可能会有 | ||
| APM(SC-1) | 颗粒 | 表面粗糙;可能腐蚀硅 | |
| HPM(SC-2) | 金属 | ||
| UPW | 冲洗 |
1.3.2.2. 先进晶圆加工清洗 ✨
前端工艺线 ( FEOL ) :单个器件在半导体晶圆上形成图案
- 预扩散清洗
- 光刻后光刻胶去除与清洗
- 后栅极蚀刻光刻胶去除与清洗
- 离子注入后光刻胶去除与清洗
- 浅沟槽隔离 (STI) 化学机械抛光后清洗
后端制程 ( BEOL ) :单个器件通过晶圆上的布线相互连接
- 预薄膜沉积清洗
- 后接触和通孔蚀刻清洗
- 后金属蚀刻光刻胶去除与清洗
- 后金属及低介电常数介质化学机械抛光清洗
1.3.2.2.1. 预扩散清洁 Pre-Diffusion Cleaning
炉前清洁至关重要,若未在高温炉操作前清除缺陷或污染物, 它们将被整合到晶圆中。这是最关键步骤,即在裸硅存在的阶段,预初始,预栅极。
通常进行彻底清洗 (食人鱼 + 缓冲氧化物蚀刻液 ( BOE, 氢氟酸) + 标准清洗 ( SC1+SC2)
1.3.2.2.2. 溶剂型清洗 (蚀刻后及后端制程)
主要用于蚀刻后清洗, 以去除光刻胶和蚀刻残留物。适用于后端工艺中存在金属层时的清洗。
抗剥离剂,有机溶剂与活性成分的专有混合物。溶剂通常为 NMP ( N‐ 甲基吡咯烷酮) 。NMP 具有水溶性, 且在水溶液中呈中性; “ 活性成分 ” 通常为胺类物质,会侵蚀光刻胶并溶解于溶剂介质中。
新型剥离剂:“ 半水性 ”, 含有有机溶剂、水、 “ 活性成分 ” 以及腐蚀抑制剂。
1.3.2.2.3. 抗蚀刻剥离
光刻胶被灰化去除,一种等离子体工艺, 可将光刻胶从表面 “ 烧蚀 ” 掉 (注: 光刻胶含有可测量的杂质, 如钠) 。灰化使杂质富集于表面,必须随后进行湿法处理以去除污染物。在晶圆上存在金属之前使用硫酸-过氧化氢混合液 ( FEOL ) ,在金属沉积 ( BEOL ) 后使用的溶剂剥离剂。
1.3.2.2.4. 蚀刻后清洗
反应离子刻蚀 ( RIE ) 过程会留下残留物 (或聚合物) 并且难以去除,因此无论是灰化还是湿润状态清洁都会被用于清洗。残留物的生成是为了抑制等离子体对蚀刻薄膜侧壁的攻击,蚀刻工艺或待蚀刻材料的变化可能需要调整清洁步骤。不同蚀刻后清洗工艺需要采用溶剂型清洗方法。
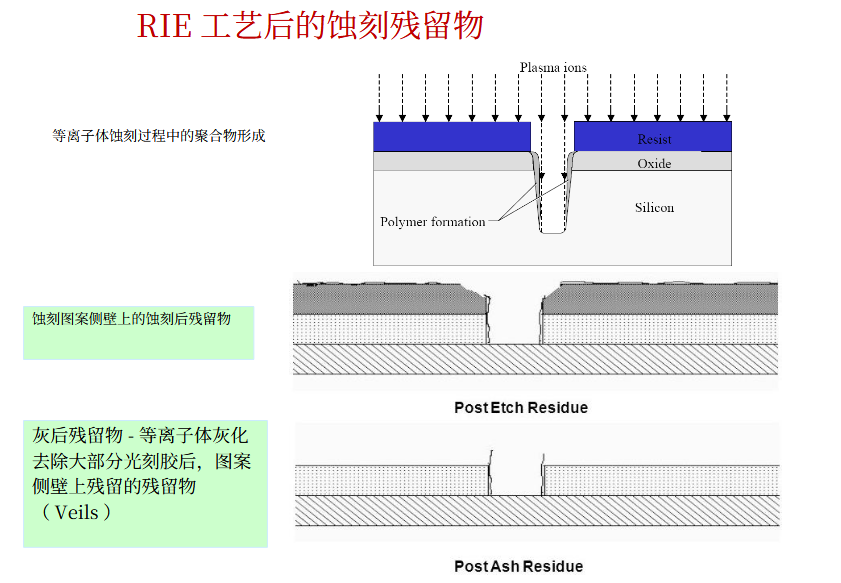
1.4. 湿法清洗设备
- 兆声波
- 喷雾清洗
- 洗涤器
- 晶圆冲洗
- 溢流冲洗槽
- 倾倒冲洗
- 喷雾冲洗
- 热去离子水冲洗
- 晶圆干燥
- 旋转干燥机
- IPA 气相干燥
1.4.1. 兆声波清洗 Megasonic Cleaning
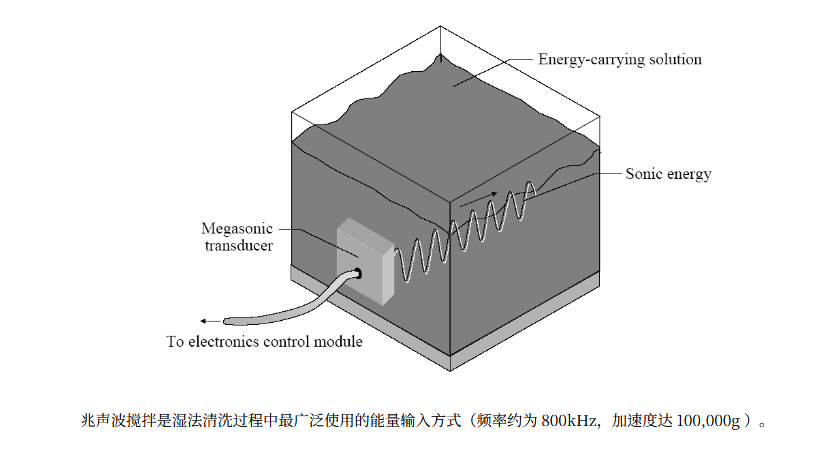
1.4.2. 后 CMP 清洗
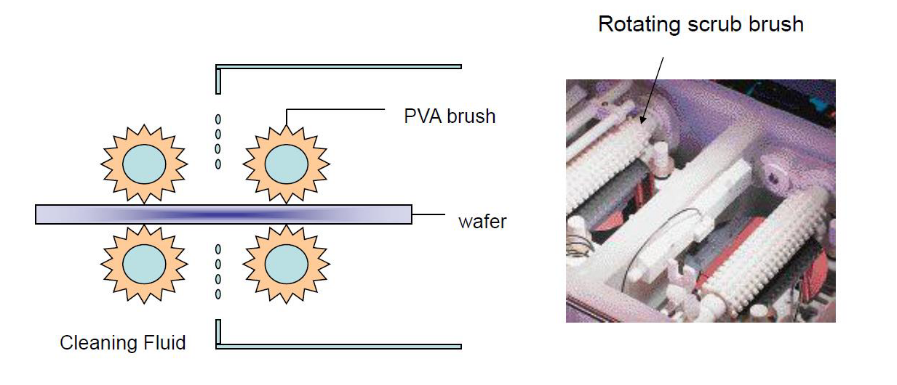
1.4.3. 水冲洗
水流持续通过晶圆表面。冲洗完成的判定是通过测量水的电阻率 (电阻率 =一种非常灵敏的检测溶液中离子存在的方法)
倾倒冲洗,适用于亲水性晶圆 热水,用于某些工艺后 (但不适用于经氢氟酸处理的表面)
1.4.4. 溢流冲洗 Overflow Rinser
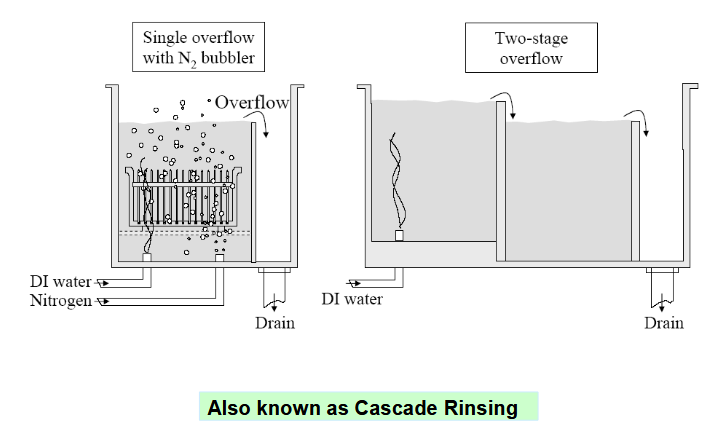
1.4.5. 排水冲洗 Dump Rinse
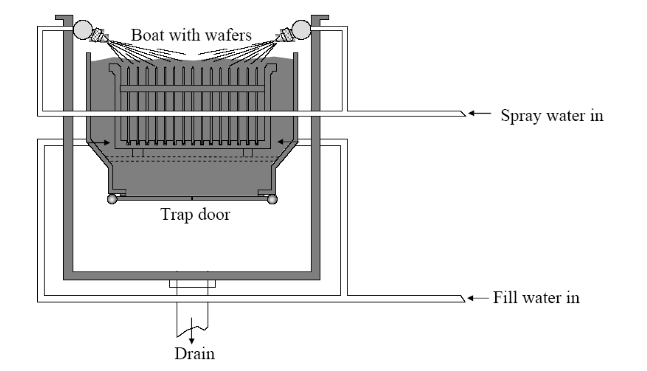
当溢流完成时, 底部的快速卸料门随即开启, 冲洗水在数秒内从槽中排出, 与此同时, 槽顶的喷嘴喷淋器在卸料过程中持续用新鲜、洁净的去离子水保持产品湿润。
1.4.6. 干燥
干燥是清洁的关键步骤,其目标在于在水干燥于表面并留下水中杂质残留物之前, 尽可能多地去除水分。
两种干燥机类型:
- 旋转冲洗干燥机 ( SRD ) ,尽可能甩除水分;
- IPA 蒸汽,用异丙醇 ( IPA ) 置换水分。
- IPA 蒸汽干燥器类型:
- 罐式;
- 蒸汽喷射式 ( VJD );
- 马兰戈尼型 Marangoni-type。
- IPA 蒸汽干燥器类型:
1.4.6.1. 旋转冲洗干燥机 (SRD)
晶圆被放入载具盒中, 载具盒以数千转每分钟的速度旋转,尽可能甩掉水分。热氮气吹扫有助于更快干燥晶圆。
1.4.6.2. IPA 环境中清洗后的马兰戈尼晶圆干燥
马兰戈尼原理涉及将晶圆从去离子水浴 (或去离子水位沿晶圆表面下降) 缓慢移至异丙醇 ( IPA ) 和氮气环境中, 使得在任何时刻, 只有处于液相与气相界面的那部分表面处于 “ 干燥中 ” 状态。
这种方法避免了晶圆上不受控制的蒸发干燥。IPA 干燥在疏水性清洗步骤 (如栅极前、硅化物前及接触前清洗) 中展现出显著优势。
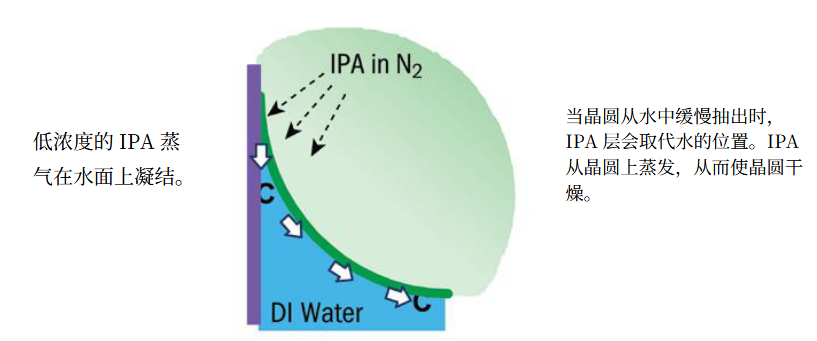
1.4.6.3. 干燥设备对比
| 旋转冲洗干燥机 (SRD) | IPA 蒸汽干燥机 | 马兰戈尼干燥机 |
|---|---|---|
| 晶圆在载具中高速旋转,通过离心力去除水分。 | 加热含有液态 IPA 的腔体,热力与冷却线圈作用使液态 IPA 形成蒸汽云,晶圆暴露于蒸汽云中干燥。 | 浸没在水中的晶圆缓慢通过 IPA 液体薄层,利用 IPA 与水的表面张力梯度干燥。 |
| 优点 | ||
| - 资本成本低 - 不消耗 IPA | - 温和的晶圆处理 - 干燥效果良好 - 可干燥晶圆载具 - 与工作台集成良好 | - 温和的晶圆处理 - 业界公认的最佳干燥方法,无水痕。 - 干燥过程中不暴露于空气 - 可进行原位氢氟酸最后处理 - 与湿法工作台集成良好 - 最佳无载具方案 |
| 缺点: | ||
| - 可能产生水痕 - 通孔可能残留水分(适用于低技术干燥) - 机械操作粗暴,偶尔导致晶圆破损 - 无无载具选项 | - 比旋转干燥成本高 - 干燥时间长于马兰戈尼 - IPA 消耗量高于马兰戈尼 | - 成本最高 - 消耗 IPA,但量极少 |
2. 化学与物理抛光 Chemical and Mechanical Polishing
2.1. IC 金属化趋势及相关的非平面拓扑结构
集成电路上器件和互连特征的关键尺寸正在减小, 而由于芯片尺寸的增加, 器件间的平均连线长度却在增加。这种特性的同步缩小与芯片面积的增加, 根据 “ 摩尔定律 ”, 每 18 个月集成电路的尺寸就会翻倍。
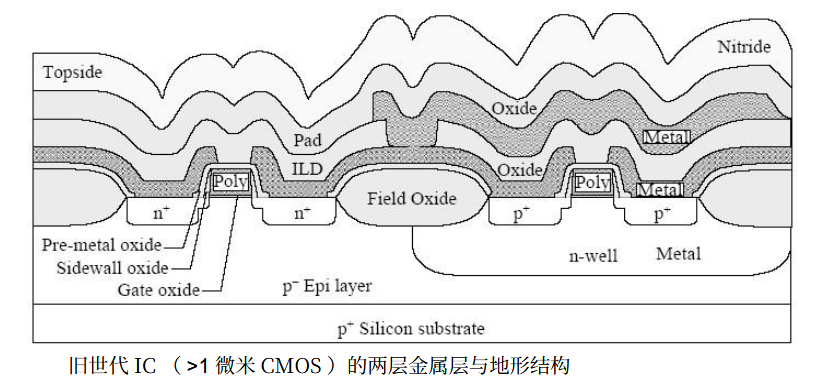
集成电路中的表面非平面性是累积的, 从原始的平坦硅晶圆开始 —— 这既由晶圆上薄膜厚度的不均匀性引起, 也由诸如栅极或布线等 IC 特征的有图案拓扑结构所导致。
用于电源和地线总线的高层金属层必须增加厚度以承载更高的电流,低电流信号总线则布置在较低层的金属层中。这种非平面拓扑结构使得金属间电介质中所有通孔的蚀刻和均匀填充变得更加困难。最终, 在达到一定程度的非平面性时, 通孔蚀刻和填充都无法以高良率实现,通孔可能未穿透介质层(断路)或过度刻蚀损伤下层金属(短路)。
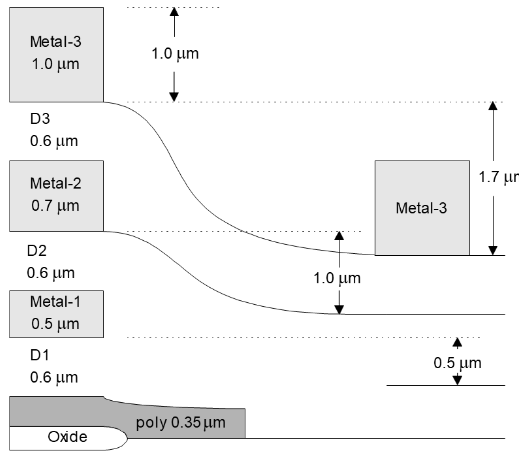
2.2. 非平面表面引发的问题
2.2.1. 问题 1: 光刻缺口
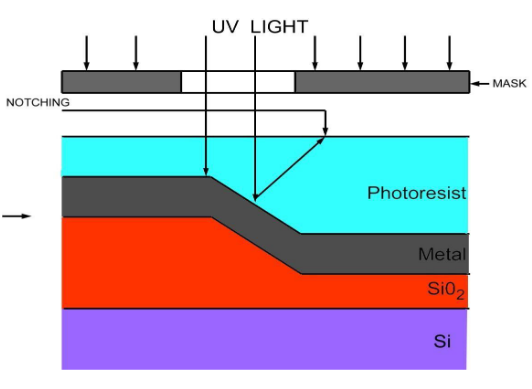
由于存在焦深,在台阶处的光反射会导致缺口现象。
平面形貌对光刻工艺的优势:
- 较低的景深要求
- 减少光反射效应对抗蚀剂轮廓的影响
- 降低台阶上抗蚀剂厚度的变化
- 更优的尺寸控制
2.2.2. 问题 2: 金属减薄
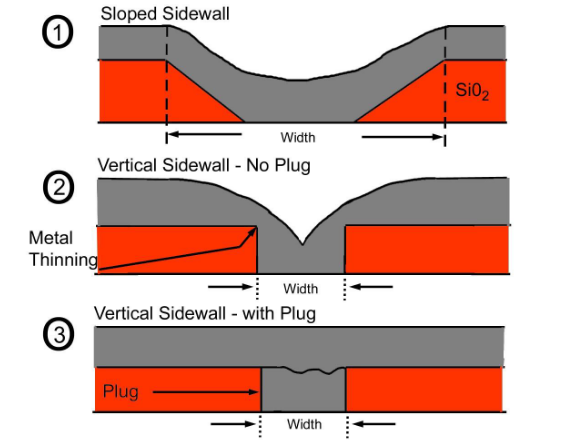
金属台阶覆盖和台阶减薄。平面地形有助于防止金属在台阶处的减薄;具有垂直塞填充的平坦化表面可防止金属台阶覆盖问题。
通过平面化能减少线路电阻,提高电迁移性能。
2.2.3. 平面化的定量定义
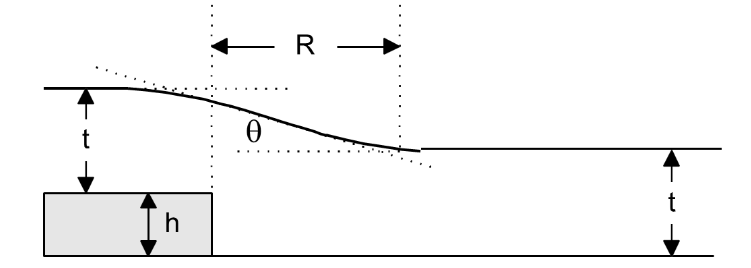
一般来说,全局平面化标准为:
2.3. 化学机械抛光 ( CMP )
CMP 是一种物理化学工艺, 用于使晶圆表面在局部和全局范围内变得平坦。
- 化学作用:
- 羟基 (OH) 离子在氧化物的 CMP 中和
反应, 导致表面软化和化学溶解; - 氧化剂增强金属溶解,并控制金属化学机械抛光中的钝化过程;
- 羟基 (OH) 离子在氧化物的 CMP 中和
- 机械作用:抛光机的旋转与压力;
CMP 的效果通过
- 关键参数抛光后不均匀性 nonuniformity ( NU ) ,
(由局部去除率变化引起的) - 重要参数去除率(RR),
2.3.1. CMP 工作方式
CMP 工作方式如下,旋转的晶圆正面朝下压在一个反向旋转的抛光垫上; 抛光垫将含有磨料的水性悬浮液 (研磨浆) 压向晶圆表面。
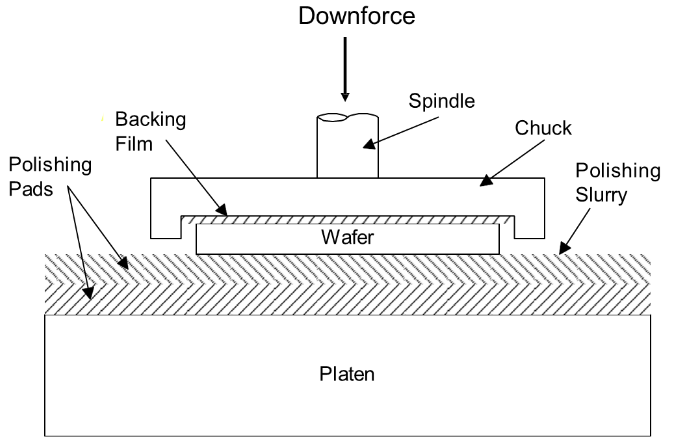
- 背衬 backing(或载体)薄膜在载体和晶圆之间提供弹性;
- 聚氨酯抛光垫,带 1 mm 穿孔,粗糙表面可容纳浆料slurry;
- 使用含有一下物质的浆料对晶圆进行抛光:
- 二氧化硅磨料(10-90 nm 粒径);
- 蚀刻剂(例如用于氧化物的氢氧化物,用于铜的 H2SO4 以控制 pH 值);
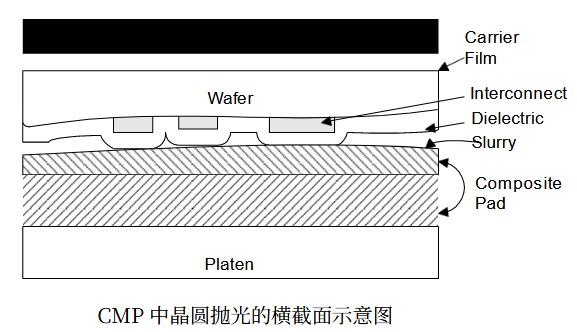
2.3.2. CMP 设备✨
2.3.2.1. CMP 抛光垫 Pad
材料为聚氨酯 polyurethane
- 硬聚合物,硬度为 55;
- 纤维桩 Fiber pile
- 比重 = 0.3
- 压缩率 = 16%
- 均方根粗糙度 = 30μm
2.3.2.2. 多晶圆载具 Carrier
提高 CMP 设备的吞吐量。
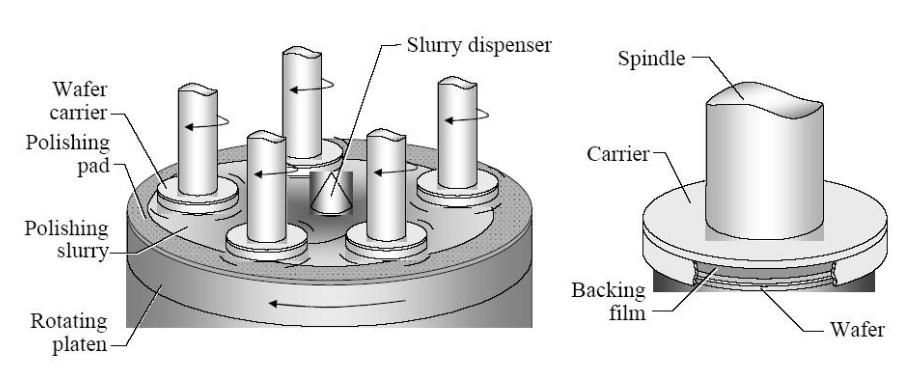
2.3.2.3. CMP 浆料 Slurry
浆料中的化学物质与表面材料发生反应, 形成可被磨料颗粒去除的化合物。浆料中的颗粒通过机械作用磨损晶圆表面并持续去除材料。
浆料在晶圆与抛光垫之间持续流动,抛光垫实际上从未接触晶圆。用于抛光氧化膜的浆料为碱性 ( pH=10
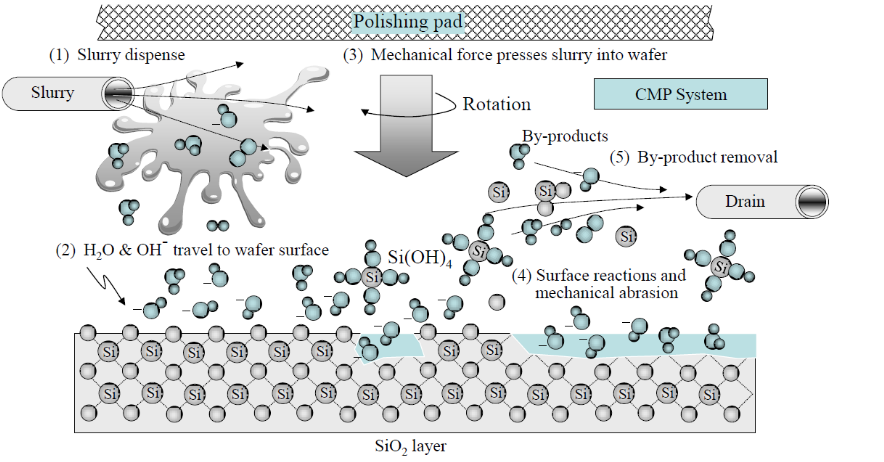
就像前面所言,
与 反应生成较软的硅酸凝胶层 ; - 浆料中的磨料去除生成的
。
| 颗粒 | 化学物质 | ||
|---|---|---|---|
| 分类 | 酸性 acidic | 碱性 alkaline | |
| 作用 | 通过机械作用磨损晶圆表面并持续去除材料 | 化学物质与表面材料发生反应, 形成可被磨料颗粒去除的化合物 | |
| 氧化金属表面 |
2.3.2.4. CMP 金属机制
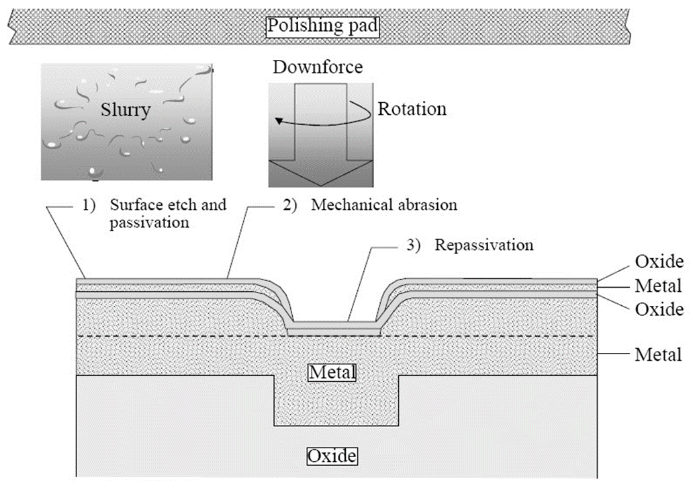
持续的氧化、钝化 passivation 和对突出的金属表面的蚀刻导致了化学机械抛光 ( CMP ) 的平坦化机制。
2.3.3. CMP 工艺特性✨
去除率:
| 变量 | 对 CMP 工艺和晶圆表面的影响 |
|---|---|
| 下压力增加 | 正面影响:提高材料去除率(MRR),加快抛光效率。 负面影响: - 加剧不均匀性(如碟形凹陷、边缘侵蚀); - 增加表面划痕和微观损伤风险; - 可能破坏脆性材料(如低介电层)。 |
| 压盘速度增加 | 正面影响:增强剪切力,提升抛光均匀性(若与压力匹配)。 负面影响: - 高速摩擦导致局部温升,可能改变化学反应平衡; - 抛光液分布不均,加剧边缘过度抛光。 |
| 抛光垫寿命增加 | 正面影响:降低更换频率,节省成本。 负面影响: - 垫表面钝化,去除率下降,需更高压力补偿; - 孔隙堵塞导致抛光液传输效率降低,均匀性恶化; - 划痕和缺陷率上升。 |
通常, 去除率 (吞吐量) 与优化工艺之间存在权衡。
薄膜去除或薄膜残留的均匀性;
选择性:
阶梯高度比
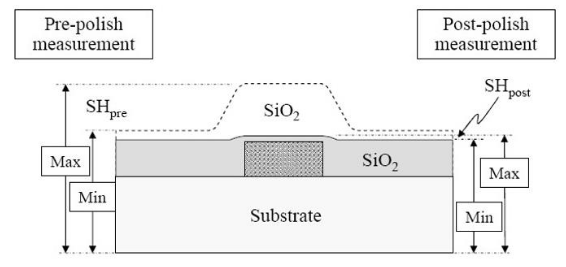
就是抛光后的阶梯高度差与抛光前的阶梯高度差的比。SHR 越小越好。
2.3.4. 化学机械抛光中的抛光终止
有以下方式来确定什么时候抛光可以终止:
- 定时抛光 Timed polish: 要求抛光速率精确、均匀性好, 且对监控要求极高。
- 电机电流端点 Motor Current Endpoint: 垫片与晶圆间电阻的变化表明薄膜已完全去除, 或表面完全光滑。
- 原位薄膜测量 In-Situ Film Measurement: 内置干涉仪通过抛光垫上的窗口测量剩余膜厚。由于晶圆表面存在浆料和形貌特征, 该过程变得复杂。
2.3.5. CMP 工艺关注点
残余浆料。浆料颗粒可能非常难以去除, 尤其是当它们陷入深孔或沟槽中时。软旋转刷与
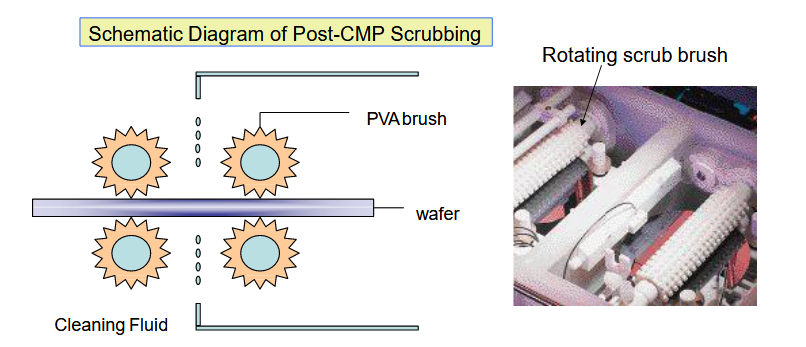
2.3.6. CMP 过程参数 ✨
- 机械 (工具)
- 晶圆上的压力 (下压力)
- 垫片与晶圆速度
- 压板温度
- 焊盘结构与条件 (老化)
- 化学浆料
- 浆料流速 ( 150‐300 毫升 / 分钟)
- 浆料化学构成
- 温度
- 浆料龄期
- 焊盘结构与调节 (老化)
2.3.6.1. 结构大小和密度对抛光后阶梯高度的影响
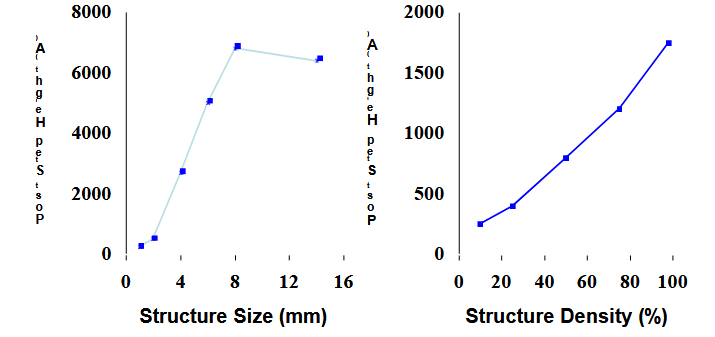
与孤立的窄线相比, 金属垫上的 SHR 更大。电路密度较低的区域比底层地形密集的区域抛光速度更快。每个电路设计由于互连线的尺寸和密度变化, 其芯片内非均匀性 (WIDNU) 会有所不同台阶高度比 (SHR)。
2.3.6.2. 下压力对去除率和平面度的影响
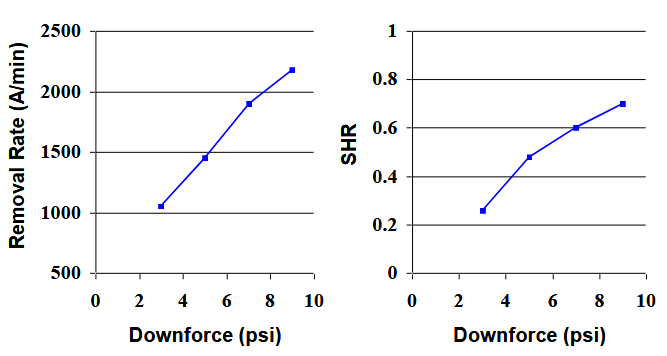
下压力 (施加在抛光垫上的晶圆压力) 的增加会导致去除率呈线性上升。下压力的增加会因抛光垫变形导致平面度下降, 进而在 “ 谷底 ” 区域造成局部压力上升。
2.3.6.3. 压板速度对去除率和平面度的影响
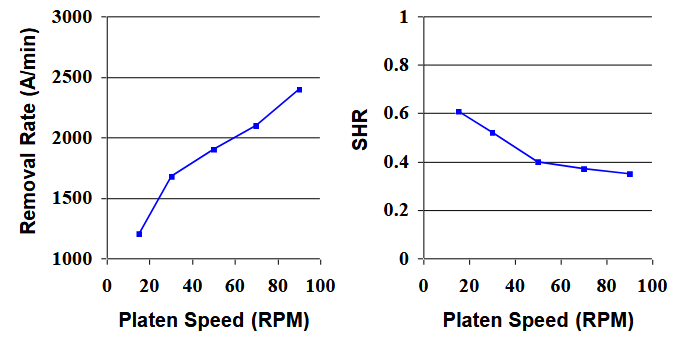
压板速度的增加线性地提高了去除率;压板速度的增加提高了平面度;在较高的速度下,抛光垫主要接触 “丘陵 ”区域,因为它没有足够的时间来适应 “山谷 ”区域
2.3.6.4. 载体速度对晶圆中心和边缘去除率的影响

压板速度保持在 70 RPM。中心到边缘的去除率差异随着载具速度的增加而增大,载体直径 << 压板直径 & 在载体低速运转时, 载体产生的线速度矢量远小于压板产生的线速度矢量。当载具速度接近并超过压板速度时, 由载具产生的线性速度矢量变得显著。
2.3.6.5. 抛光垫硬度对抛光后台阶高度和平坦化距离的影响
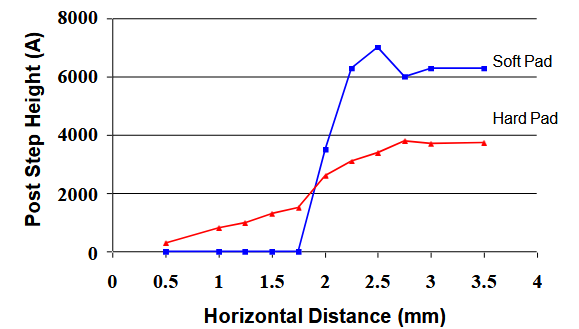
较硬的抛光垫在压力下变形较小,因此:
- 较低的阶梯高度比、更高的平面化距离和改进的芯片内不均匀性 Within-Die Non-Uniformity(即在毫米范围内)
- 更差的晶圆内部不均匀性 Within-Wafer Non-Uniformity(即在厘米范围内)
较硬的焊盘也会导致更高的去除率和更高的缺陷密度。
2.3.6.6. CMP 工艺参数总结
| 参数 | 对晶圆平坦化效果的影响 |
|---|---|
| 抛光时间 | • 材料去除量 • 平坦度 |
| 晶圆载具压力 (下压力) | • 去除速率 • 平坦化效果及不均匀性 |
| 抛光盘转速 | • 去除速率 • 不均匀性 |
| 载具转速 | • 不均匀性 |
| 研磨液化学性质 | • 材料选择性 • 去除速率 |
| 研磨液流速 | • 影响抛光垫上的研磨液量 • 影响系统润滑特性 |
| 抛光垫调节 | • 去除速率 • 不均匀性 • CMP 工艺稳定性 |
| 晶圆/研磨液温度 | • 去除速率 |
| 晶圆背压 | • 中心区域速度减慢/不均匀性 • 晶圆破损风险 |
2.3.7. CMP 后清洗
CMP 后清洗能在抛光后去除颗粒物和化学污染物,包含缓冲、刷洗、兆声波清洗、旋转冲洗干燥等步骤。
缓冲:
-
在主抛光之后, 晶圆使用软垫进行 “ 抛光 ”
-
应用于金属化学机械抛光后
-
使用氧化物浆料、去离子水或 NH4OH
- 改变系统 pH 值以降低金属颗粒的附着力
- 去除晶圆中嵌入的金属颗粒
-
可减轻清洗负荷
-
刷洗清洁
- 采用孔隙率达 90% 的 PVA 材质刷具;
- 通常为双面擦洗、滚筒式或圆盘式;
- 刷头可能与晶圆直接接触;
- 添加 NH4OH ( 1‐2% ) 以去除颗粒 (防止再沉积), 加入柠檬酸 ( 0.5% ) 用于金属去除, HF 蚀刻氧化物以消除亚表面缺陷;
-
兆声波清洗
- 声波为粒子注入能量, 减薄边界层
- 添加清洗化学品 (如 SC1 等)、
- “ 声流 ” 效应引发粒子表面流动
-
旋转冲洗干燥
- 清洗后, 晶圆高速旋转
- 开始时向晶圆喷洒水和 / 或清洗液 ( SC1 )
- 流体力学作用使溶液从晶圆上排走
- 可能对清洗效果无直接影响, 但确保前序步骤中从晶圆脱落的颗粒不会重新沉积
2.4. CMP 优缺点
| 分类 | 项目 | 详细说明 |
|---|---|---|
| 优势 | 平坦化能力 | 实现全局平坦化,可处理多种晶圆表面 |
| 多材料平坦化 | 同一抛光步骤中可平坦化多种不同材料 | |
| 复杂表面处理 | 显著降低表面形貌,满足更严格的设计规则和多层互连要求 | |
| 金属图案化替代方案 | 提供金属图案化新方法 (如镶嵌工艺),避免难蚀刻金属的等离子体蚀刻 | |
| 金属台阶覆盖改善 | 通过降低表面形貌改善金属台阶覆盖 | |
| 提高 IC 可靠性 | 提升亚 0.5μm 器件和电路的可靠性、速度和良率 (降低缺陷密度) | |
| 缺陷消除 | 作为减法工艺可去除表面缺陷 | |
| 无危险气体 | 不使用干法蚀刻中常见的有害气体 | |
| 劣势 | 新兴技术 | 晶圆平坦化的新技术,工艺参数控制相对较差,工艺窗口窄 |
| 新型缺陷 | 会产生新型缺陷,对亚 0.25μm 特征尺寸影响尤为关键 | |
| 需额外工艺开发 | 需要额外开发工艺控制和计量方法,如终点检测难以控制目标厚度 | |
| 高运营成本 | 设备耗材昂贵,需要高维护频率,化学品和部件更换频繁 |
3. 计量与分析技术 Metrology and Analytical Techniques
3.1. 光学特性表征 Optical Characterization
主要关注光学显微镜、椭偏仪、传输、光致发光这四个表征方式。
3.1.1. 光学显微镜 Optical microscopy
由于光的衍射特性, 无法将其聚焦到一个无限小的点上。但是理论上能检测的单个孤立物体的尺寸没有下限,只要其散射或发射的光信号足够强(信噪比高),仍可被探测到,但是无法分辨细节。
所以两点最小分辨距离是考瑞利判据来判断的,
两点最小可分辨距离
指向原始笔记的链接
为自由空间波长; 为浸没介质的折射率; 为透镜在物体处所张半角; 为数值孔径。

3.1.2. 椭偏仪 Ellipsometer
椭偏仪通过分析偏振光在样品表面反射后的偏振态变化,测量材料的光学性质(如折射率、消光系数、薄膜厚度等)。其核心在于测量椭偏参数
其基本结构与光路如下,
- 光源:单色光(如激光)或宽谱光源,波长范围通常为可见光至近红外。
- 起偏器(Polarizer, P) :将入射光变为线偏振光。
- 补偿器(Compensator, C) :通常为四分之一波片,将线偏振光转为椭圆偏振光。
- 样品台:放置待测样品(如硅基薄膜)。
- 检偏器(Analyzer, A) :检测反射光的偏振态。
- 探测器:测量光强信号
角度 P 、 C 和 A 导致椭偏仪量

其是一种无损检测技术,
- 薄膜厚度测量:可测量薄膜厚度低至 1 纳米
- 折射率测定:可测量未知厚度薄膜的折射率
- 方位角高精度测量:可非常精确地测量方位角
- 高精度与可重复性
- 测量两个值的比率(如振幅比、相位差)
- 即使在低光照条件下仍保持高精度
- 无需参考样本,无需依赖标准样品进行校准
- 抗干扰能力,不易受散射、灯光或净化波动的影响
- 表面均匀性评估
- 成分测定
- 原位(in situ)分析,支持实时动态监测,无需破坏样品环境
3.1.3. 透射/吸收
定义:吸收,即通过将电子从低能态激发至高能态的过程, 导致入射光通量中光子的损失。
通用方案: 光线照射在薄样品上, 部分光被反射, 其余部分被吸收或透射; 对透射光的强度进行测量。实验可以作为一个温度函数来进行, 外部施加的场、样品厚度等。
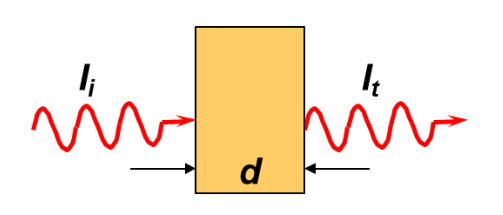
3.1.4. 光致发光 Photoluminescence
入射激光产生电子-空穴对 (ehp)。当 ehp 复合时, 会释放出光。
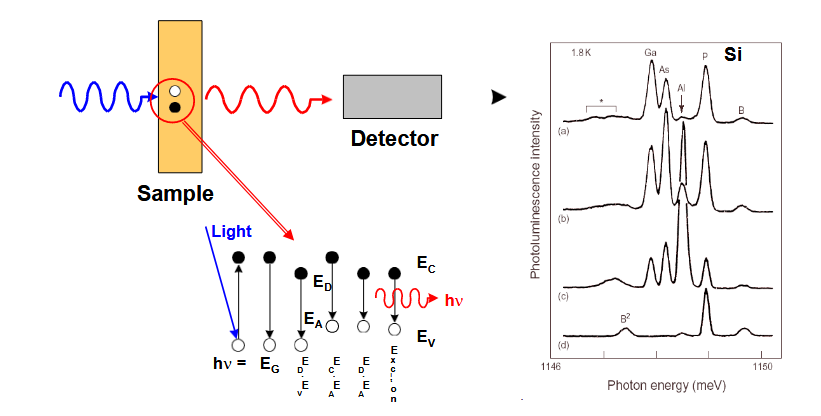
光致发光(PL)检测机制与应用
| 检测机制 | 主导条件/物理过程 | 检测信息 | 应用场景 | 技术手段 | 优点 | 限制 |
|---|---|---|---|---|---|---|
| 肖克莱-里德-霍尔(SRH)复合 | 杂质或缺陷作为复合中心,非辐射复合主导 | 杂质浓度、缺陷密度 | 硅片中金属污染检测,晶体质量评估 | 微波光电导衰减法(μ-PCD)、时间分辨 PL | 高灵敏度(ppm 级杂质检测) | 受表面复合影响大 |
| 俄歇(Auger)复合 | 高载流子密度(n > 10¹⁸ cm⁻³),三粒子碰撞 | 重掺杂浓度(如 n⁺/p⁺区) | 功率器件掺杂均匀性分析,激光二极管热管理 | 变温 PL 光谱、电致发光(EL) | 可区分俄歇与 SRH 机制 | 需高注入条件,可能损伤样品 |
| 辐射复合 | 直接带隙材料(如 GaAs、InP)的带间跃迁 | 带隙能量、激子峰、缺陷发光峰 | 材料带隙测量,量子阱/点结构表征 | 稳态/瞬态 PL 光谱、显微 PL 成像 | 非破坏性,空间分辨率达微米级 | 仅适用于直接带隙材料 |
| 表面态复合 | 表面缺陷捕获载流子,增加表面复合速率(S) | 表面缺陷密度、钝化效果 | 太阳能电池表面钝化工艺优化 | 表面光电压(SPV)、开尔文探针力显微镜(KPFM) | 直接反映表面电学特性 | 需真空环境(部分技术) |
| 深度分辨分析 | 波长选择调控载流子生成深度(短波长→浅层) | 薄膜/异质结的界面质量、体内均匀性 | 多层结构(如 LED 外延片)的缺陷定位 | 多波长激发 PL、共聚焦 PL 显微术 | 非破坏性层析分析 | 需高精度光学系统 |
3.2. 基于电荷的表征 Charge-Based Characterization ✨
电荷以化学方式或通过电晕电荷(流体的电离)沉积在晶片上测量;非接触式表面电压/表面光电压;可以通过光增强测量。
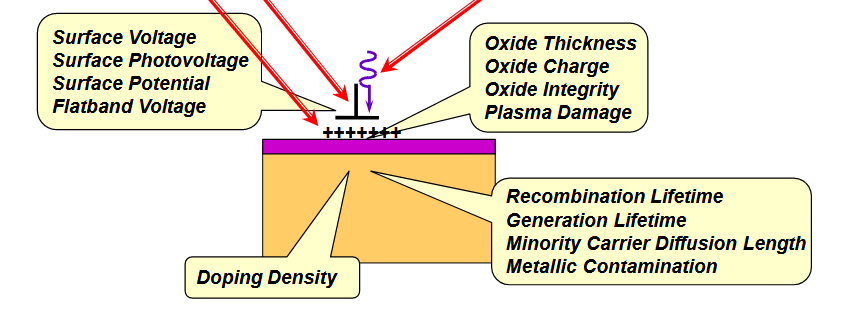
3.2.1. 扫描隧道显微镜
STM 依赖于电子通过空气间隙的隧穿效应,用于原子级成像表面。产生的隧道电流是针尖位置、施加电压以及样品局域态密度 ( LDOS ) 的函数。它需要极其洁净和稳定的表面、尖锐的针尖、卓越的振动控制以及精密的电子设备。
3.2.2. 原子力显微镜
原子力显微镜(Atomic Force Microscope, AFM)是一种通过探测探针与样品表面之间的相互作用力来实现纳米级分辨率成像的仪器。
压电扫描器保持针尖的恒定高度来测量力信息或者恒定力来测量高度信息。探针通常由
有不同的工作模式,
-
接触模式(高分辨率)
- 针尖以与表面紧密接触的方式扫描样品;针尖上的排斥力约为 10-8 N;该力通过使用压电元件将样品压向悬臂梁来设定;压电电压与样品高度成正比;
-
非接触模式(低分辨率)
- 针尖位于样品表面上方 5‐15 纳米处。通过检测针尖与样品之间作用的范德华吸引力, 并在表面上方扫描针尖, 从而构建出形貌图像。
-
轻敲模式 Tapping mode
- 悬臂梁以其共振频率 ( 50‐500 kHz ) 振荡。当探针未与表面接触时, 悬臂以高振幅 (约 20 纳米) 振荡然后, 振荡的探针向表面移动, 直到开始轻微接触或轻敲表面;
- 振荡幅度减小,振荡幅度的减小用于测量表面特征
-
测量线宽与探针形状相关
- 通过分析标准样品获得的尖端形状
- 真实轮廓由已知探针尖端形状获得
-
探针形状, 弯曲稳定性
-
压电扫描线性度
-
低吞吐量
3.3. 电子束表征 Electron Beam Characterization
电子束特性:
- 反射
- 扫描电子显微镜
- 低能电子衍射
- 高能电子衍射
- 电压对比
- 发射
- 俄歇电子能谱
- 阴极发光
- 电子探针
- 吸收
- 电子束感生电流
- 透射
- 透射电子显微镜
- 电子能量损失谱
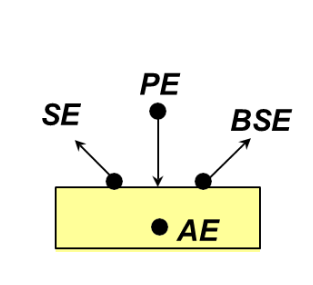
初级电子 ( PE ) 入射到固体上会产生: 吸收电子 (AE);二次电子 (SE);背散射电子 (BSE)。二次电子产额在
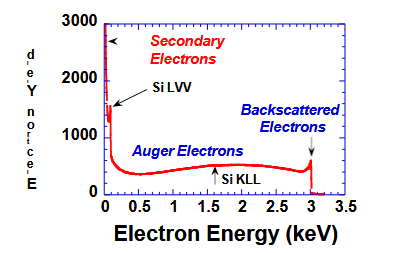
当电子束射入固体的时候,电子会扩散到
在
3.3.1. 扫描电子显微镜
电子与样品中的原子相互作用, 产生包含样品表面形貌和成分信息的各种信号。
- 常规用于半导体
- 线宽
- 拓扑
- 阴极发光,光发射
- 电子微探针,X 射线发射
对比度取决于电子的入射角。
3.3.2. 透射电子显微镜
电子被加速至 ~100– 300keV,样品必须非常薄, 以防止电子扩散。
3.3.3. 电子探针显微分析仪 ( EMP )
与 SEM 类似, 但用于检测 X 射线。入射电子将 K 壳层电子击出,L 壳层电子填补空位 (空穴) ,能量以 X 射线形式释放。
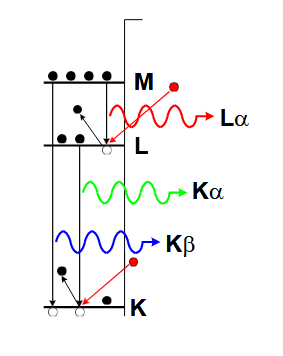
电子探针是一种无损技术; 单次分析即可检测痕量杂质与主要成分。通过扫描束获取二维信息
3.4. 离子束表征 Ion Beam Characterization
- 反射
- 溅射
- 二次离子质谱法
- 卢瑟福背向散射
- 发射
- 光子光谱
- 粒子诱导 X 射线发射
- 电子发射
- 吸收
- 离子注入
3.4.1. 二次离子质谱法
二次离子质谱 (SIMS) 是最常见的掺杂分布分析方法。
原理: 样品溅射出的原子; 分析喷射离子的质量。离子质量可以用于元素识别; 离子强度可以分辨元素密度。
优点: 提供深度剖面分析。能够分析所有元素; 在所有方法中灵敏度最高分析技术。可同时测量多种杂质
破坏性方法。受基体效应影响: 离子产率随表面成分变化而改变。需标准品用于浓度测定, 独立的深度测量
敏感性: 取决于杂质。最高灵敏度为硅中的硼, 在
3.4.2. 卢瑟福背散射
经典实验。具有数兆电子伏特能量的氦离子被样品原子散射。样品原子的质量通过散射离子的能量确定
3.5. 工作原理总结
| 表征介质 | 表征工具 | 工作原理 |
|---|---|---|
| 光学表征 | 光学显微镜 | 反射 |
| 椭圆偏振法 | 反射 | |
| 吸收系数 | 透射 | |
| 光致发光 (PL) | 发射 | |
| 红外光谱 (IR) | 透射 | |
| 电子表征 | 扫描电子显微镜 (SEM) | 反射 |
| 透射电子显微镜 (TEM) | 透射 | |
| 电子探针 | 发射 | |
| 离子表征 | 二次离子质谱 (SIMS) | 反射 |
| 卢瑟福背散射 (RBS) | 反射 |
[! tip] 这里工作原理的分类大概是这么个意思:最后引发你看到的现象的粒子是怎么来的。假设最初发射出来的粒子为
,如果你看到的是被激发出来的 ,那就是发射;如果是反弹后的 ,那就是反射;如果是传过了测试样品的 ,那就是透射。
4. 用于 CMOS 技术的电介质 Dielectrics for CMOS technology
4.1. 缩放导致的问题
- 热力学: 源极与漏极中的掺杂浓度
- 物理学: 穿过薄栅氧化层的隧穿效应
- 统计: 体掺杂的统计涨落
- 经济: 工厂成本
同样,随着缩放使得
4.1.1.
其主要用处有:
- 钝化 (保护) 半导体表面的高场区域
- 选择性离子注入的掩蔽
- 非常好的蚀刻选择性
- 作为MOS晶体管栅极区域的绝缘层
- 稳定且可重复的Si/SiO2界面
- 最终电路保护等
4.2. 生成
用于生成二氧化硅的方法一般就:热氧化 Thermal oxidation或者 CVD Chemical Vapor Deposition。
4.2.1. 重要特性
- 优异的介电性能:
- 电阻率
;带隙 ; - 高击穿电场
- 界面钝化。
- 稳定且可重复的体特性
- 稳定且可重复的
界面 - 完美粘附性与低针孔密度
- 电阻率
- 良好的掩膜性能
- 对掺杂剂的低扩散性
- 易于选择性蚀刻硅
4.2.2. 热氧化
4.2.2.1. 氧化物生长的动力学 (Deal-Grove 模型)
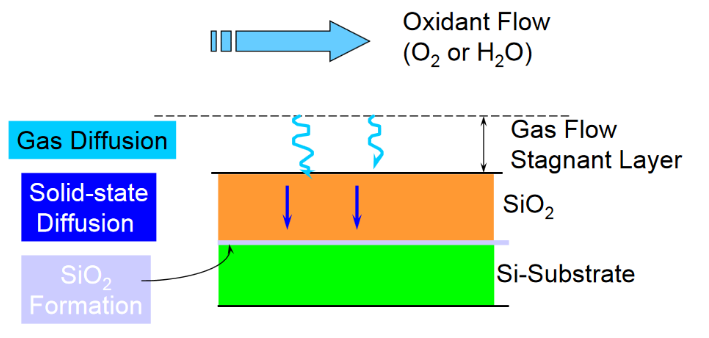
硅的氧化发生在氧化剂 O2 或 H2O 与 Si 反应生成 SiO2 时。氧化过程可能的途径是氧化物质 O2 或 H2O 扩散通过不断生长的氧化层, 随后与硅表面发生反应。
生成的二氧化硅在体积上扩展了 2.2 倍。同时会有压缩应力,当
通过热氧化生成的
4.2.2.1.1. 硅消耗厚度 (平面氧化)
4.2.2.1.2. 氧化速率
B/A 称为线性速率系数(情况
4.2.2.1.3. 氧化物生长
初始生长阶段:
氧化物形成动力学(Deal-Grove 模型)非常适用于湿式氧化,有水蒸气的情况下,氧化速率会更快。一方面水分子更小更容易传过氧化层与基底接触进行反应,另一方面羟基(
氧化速率的取向依赖性:
- 生长速率取决于 Si 原子的表面密度。
- Si (111) 表面原子密度 > Si (110) 表面原子密度 > Si (100) 表面原子密度
- Si (111) 表面氧化物的生长速率 > Si (110) 表面氧化物的生长速率 > Si (100) 表面氧化物的生长速率。
- 生长速率取决于线性速率常数。抛物线生长速率(与扩散率相关)与晶体取向无关。
4.2.2.2. 热氧化的应用
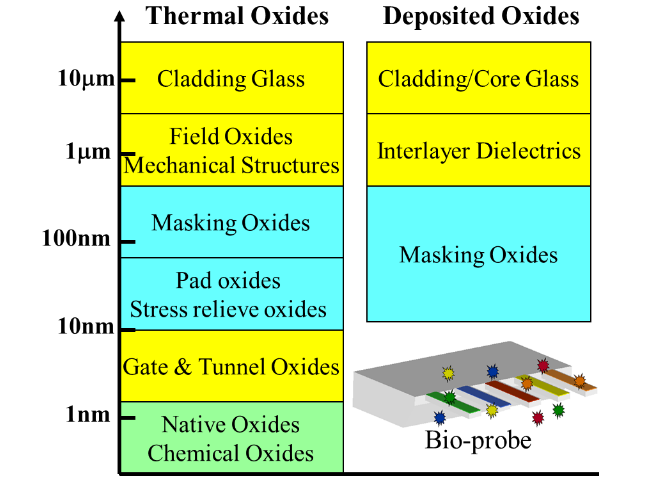
这里可以看出,如果需要非常薄的
4.2.2.3. 热氮化 Thermal Nitridation

| 热生长 | CVD |
|---|---|
| 氧气来自气相,硅来自基底 | 氧气和硅都来自气相 |
| 二氧化硅层会生长进入硅层 | 在硅层的表面 |
| 高质量 | 低温度和高生长率 |
4.2.2.4. 干法氧化与湿法氧化✨
| 特性 | 干法氧化( | 湿法氧化( |
|---|---|---|
| 氧化剂 | 纯氧气( | 水蒸气( |
| 温度范围 | 1200-700 | 1200-920 |
| 生长速率 | 慢(适合精确控制超薄层) | 快(难以控制纳米级厚度) |
| 氧化层质量 | 高致密性、低缺陷密度 | 疏松多孔、含羟基(−OH−OH)缺陷 |
| 界面态密度 | 极低( | 较高( |
| 适用厚度范围 |
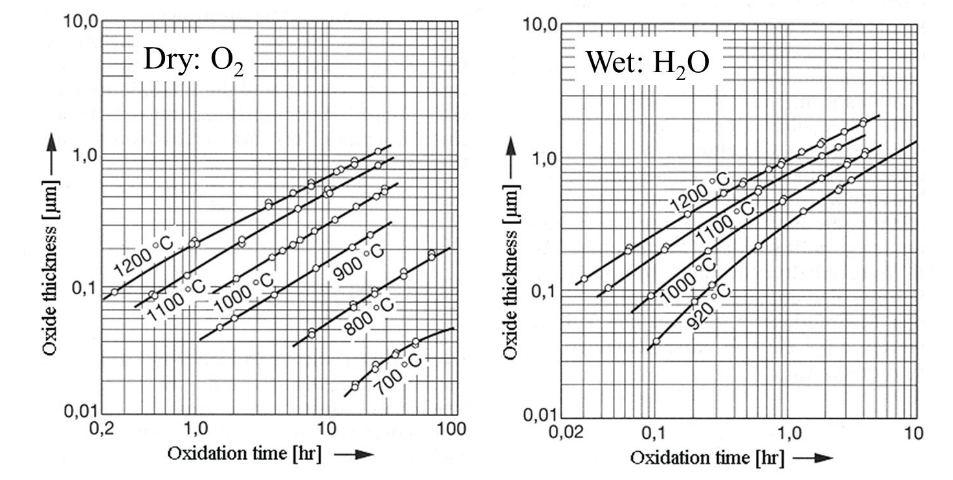
4.2.3. 化学气相沉积(CVD)工艺流程
化学气体或蒸气在固体表面发生反应, 生成固态副产物以薄膜形式附着于表面。其他副产物具有挥发性, 会离开表面。
以下是化学气相沉积(CVD)的标准化工艺流程,按步骤分类说明:
- 前驱体引入与输运
- 气相前驱体引入反应器:反应气体(如 SiH₄、TEOS、NH₃ 等)通过载气(如 N₂、Ar)送入反应室。
- 穿过边界层:前驱体分子从气相主体扩散通过停滞的边界层(Boundary Layer),到达基底表面。
- 表面吸附与迁移
- 前驱体吸附:气体分子在基底表面发生物理或化学吸附(如 SiH₄ 吸附在 Si 表面)。
- 表面迁移:吸附的分子在表面扩散,寻找能量有利的成核位点(如台阶、缺陷处)。
- 化学反应与成核
- 表面反应:前驱体分解或与其他气体反应(如 SiH₄ → Si + 2H₂),生成固态产物和气态副产物。
- 晶核形成:固态产物(如 Si、SiO₂)在表面形成离散的晶核(Islands)。
- 薄膜生长与合并
- 岛状生长(Volmer-Weber 模式):晶核逐渐长大为三维岛状结构。
- 连续薄膜形成:岛状结构通过横向生长和合并(Coalescence),最终形成连续薄膜。
- 副产物去除
- 气态副产物解吸:反应生成的挥发性副产物(如 H₂、HCl)从表面脱附。
- 扩散与排出:副产物扩散穿过边界层,随气流排出反应器。
4.2.3.1. 大气压化学气相沉积
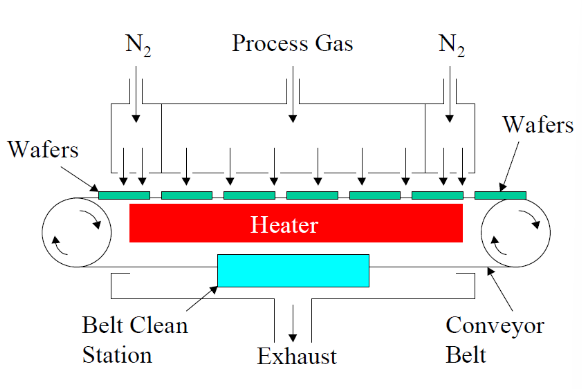
CVD 工艺在大气压下进行 APCVD 工艺已用于沉积氧化硅和氮化硅 APCVD O3-TEOS 氧化工艺广泛应用于半导体行业,尤其是在 STI 和 PMD 应用中 带有原位皮带清洁器的传送带系统
4.2.3.2. 低压化学气相沉积
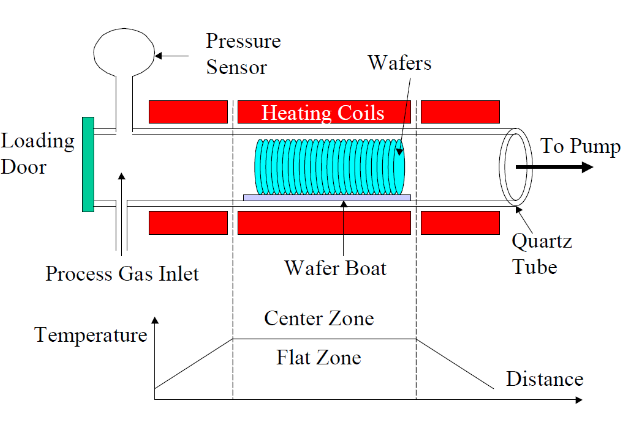
更长的 MFP
- 良好的台阶覆盖率和均匀性
- 晶圆垂直装载
- 更少的颗粒,提高生产率
- 更少的气流依赖
- 垂直和水平炉体 适用于水平管式炉
- 低压:0.25 至 2 Torr
- 主要用于多晶硅、二氧化硅 和氮化硅薄膜
- 每批次可处理 200 片晶圆
4.2.3.3. 等离子体增强化学气相沉积
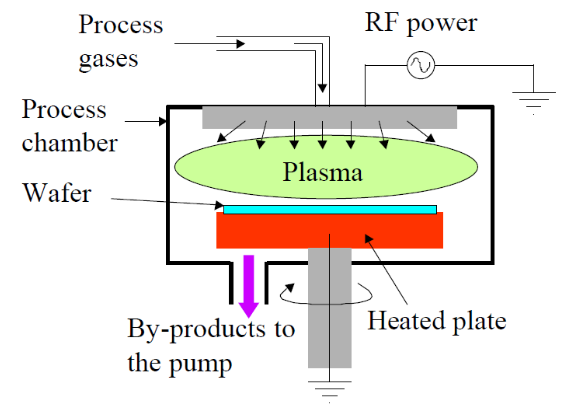
采用氮化硅替代二氧化硅作为钝化层。 在相对较低的温度下实现高沉积速率。 射频在沉积气体中诱导等离子场。 通过射频控制应力。 腔体等离子清洁。
4.2.4. 介电薄膜特性
4.2.4.1. 折射率
折射率
折射率(
)也称折射系数,指光在真空中的速度(光速, )跟其进入介质后的相速度( )之比,即: 折射率决定了进入材料时光的路径弯曲或折射的程度。这是通过描述斯涅耳定律得到的结果。折射率还决定了反射的光量到达界面时,以及全内反射和布鲁斯特角的临界角。
指向原始笔记的链接
常用椭偏仪进行测量,适用于介电薄膜工艺。可以用于确定薄膜沉积速率、湿法蚀刻速率、收缩率。
4.2.4.2. 厚度
目视检查,不同的二氧化硅厚度意味着不同的反射光。

4.2.4.3. 一致性
需要进行多点测量以确定其平均厚度以及标准差。
平均厚度,
标准差,
标准偏差不均匀性,
4.3.
4.3.1. 电介质劣化机制
在工作和制造过程中都可能劣化,
- 器件运行过程中,由于高电场导致电流注入而导致的劣化;
- 制造过程中,由于等离子体处理过程中的充电而导致的劣化
陷阱,在物理学中,是指固体(通常是半导体或绝缘体)内限制电子和空穴运动的任何位置。
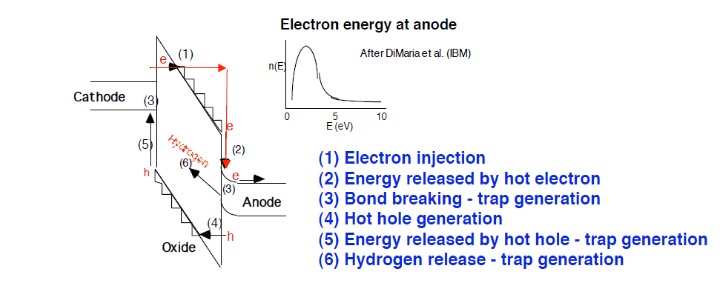 陷阱能够捕获并固定电子或空穴, 阻止其作为电子-空穴对与相反电荷的载流子复合。电子和空穴可能迅速从陷阱中挣脱, 也可能在其中停留较长时间。
陷阱能够捕获并固定电子或空穴, 阻止其作为电子-空穴对与相反电荷的载流子复合。电子和空穴可能迅速从陷阱中挣脱, 也可能在其中停留较长时间。
4.3.2. 内部电介质击穿

损伤始于阳极和阴极界面,导致性能下降。最终蔓延至整个电介质主体,导致击穿。如果能防止界面损伤,则可以最大限度地减少性能下降
4.3.3. 外部击穿
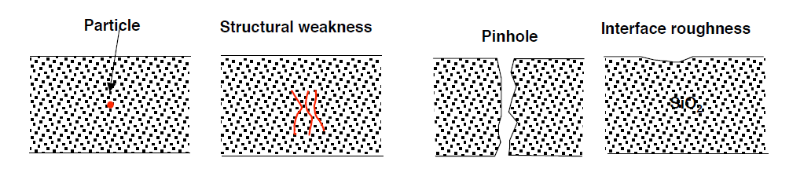
损伤始于氧化物中存在的外部缺陷,最终蔓延至整个电介质主体导致击穿。通过精心加工以减少工艺引起的缺陷,最大程度地降低性能下降。
4.3.4. 击穿统计
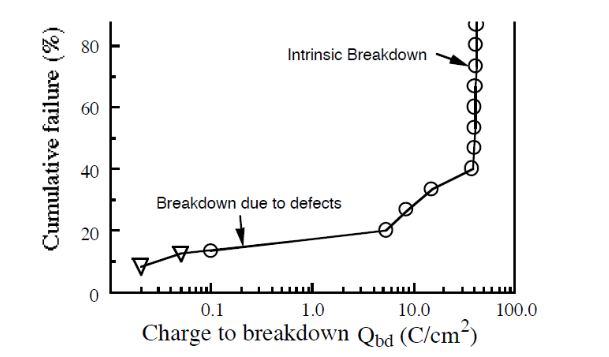
- 内部击穿需要更高的 Qpd
- 外部击穿会导致早期击穿
- 一套好的器件不应该出现厄利击穿
4.3.5. 衬底界面处的过渡层(应变层)
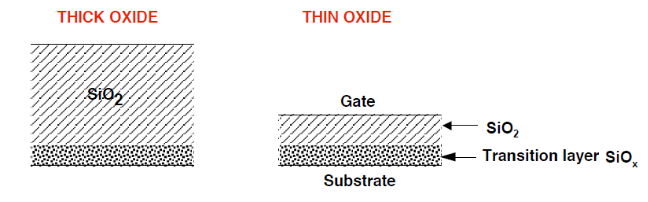
- 由于从 Si 到 SiO2 的转变而导致的结构不均匀性(1-2 个单层)
- 由于 SiO2 形成过程中的体积变化而产生的应力。
- 应变键更容易断裂,导致栅极电子注入的
- 对于较薄的薄膜,过渡层占整个层的比例很大。
为了提高深亚微米器件的可靠性,必须开发技术来降低过渡层的影响。
4.4. 氮化
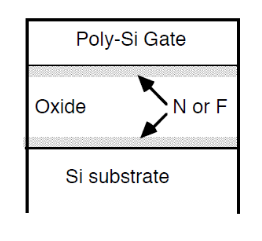
在
氮氧化物 Nitroxides
- 通过 NH、N2O、NO 对 SiO2 进行氮化
- N2O 中的生长
- 提高可靠性
- 阻挡掺杂剂从多晶硅栅极渗透
- 钾离子略有增加
- 广泛使用
氟化 Fluorination
- 通过 F 离子注入对
- 提高可靠性
- 增加硼从 P+ 多晶硅栅极的渗透
- 降低钾离子浓度
- 未有意使用
- 可能在加工过程中发生(
4.5. 高 k 介质
4.5.1. MoS 栅极电介质的要求
- 高介电常数 = 沟道中感应电荷更高
- 宽带隙 ⇒ 更高势垒 ≥ 更低漏电
- 能够在硅上生长具有洁净界面的高纯度薄膜。
- 高电阻率和击穿电压。
- 低体陷阱密度和界面陷阱密度。
- 与衬底和顶部电极兼容。
- 最小的相互扩散和反应
- 在生长和器件加工过程中,硅的再氧化最小。即使是薄的 SiO2 层也会显著损坏栅极电容。
- 热应力:大多数氧化物的热膨胀系数都比硅大。
- 良好的硅制造工艺兼容性。
- 在更高的加工温度和环境下保持稳定性
- 易于清洗、蚀刻等。
4.5.2. 高介电常数介质
在缩放后,为了保持漏极电流恒定,需要减小
通过减小厚度或者使用高 K 介质都能增加栅极电容。从而可以减少漏电流、减小功耗。
4.5.3. 先进技术中高 k 介电质的形成✨
- 在氧气和
- 在高温下于
- 在底层氧化硅层上沉积氮化硅层
- 真正高 k 介电质的沉积
氮化硅的介电常数是氧化硅的两倍;但是有更窄的带宽。
硅的氮化有以下方法,
- Si 与
- 优异的栅极介电性能
- 反应需要极高的温度
- Si 与原子氮反应
- 反应温度可通过使用氮等离子体降低
- 需要进一步研究
多种沉积方法正在研究中,例如快速热化学气相沉积 (CVD)、喷射气相沉积 (JVD)
高 K 栅极电介质的候选材料。
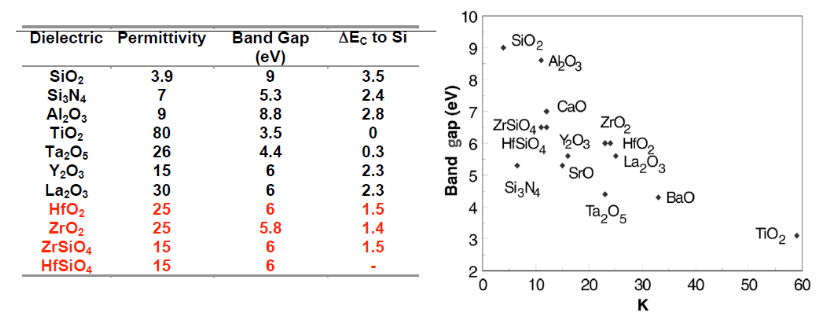
- 更高 K 的材料具有更低的带隙
- 仍有许多性能、可靠性和工艺集成问题有待解决
- 需要更多研究才能使这些材料可制造
- 宽带隙 → 更高的势垒 → 更低的泄漏
4.5.4. 高 K 材料的热稳定性
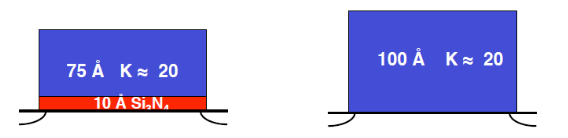
- 不稳定氧化物(例如
- 在热退火后与 Si 发生反应形成 SiO2 和硅化物
- 需要阻挡层(例如
- 电介质堆叠:多晶硅/氮化物/不稳定氧化物/氮化物/Si 衬底
- 栅极电介质两侧的单层氮化物已使物理氧化物厚度增加 5 A
- 稳定氧化物(例如 HfO2、ZrO2、Al2Os)及其硅酸盐(例如
- 在热退火(最高 1000°C)后不与 Si 发生反应
- Si 和金属氧化物之间可能不需要阻挡层
- 简单结构:多晶硅/稳定氧化物/Si 衬底
4.5.5. 高 k 栅极电介质也可应用于其他半导体
Ge 与 GeOxNy、ZrO2 和 HfO2 的钝化 第 1 次高 k Ge MOSFET 演示 p-MOSFET 迁移率是高 k Si 的 3 倍 许多其他材料的钝化实验正在进行中,例如碳纳米管、GaAs 等。
4.5.6. 高 k 材料的问题
问题
- 低带隙
- 低势垒高度
- 低击穿电场
- 不良绝缘体/Si 界面
- 薄 SiO2 介面
- 氧化物电荷
- 低电子/空穴迁移率
- 应变 Si
与 mos 工艺兼容性问题
4.5.7. 高 k 材料与低 k 材料
- 低 k 材料和铜用于未来互连
- 高 k 电介质用于栅极或 DRAM 电容器
低 k 电介质是一种绝缘材料,在外部施加电场时表现出弱极化。设计低 k 材料的一些实用方法包括:
- 选择非极性电介质体系。例如,在极性化学基团较少且具有对称性以抵消不同原子之间化学键偶极子的材料中,极性较弱。
- 由于
- 原子间距较远的材料(记住
- 增加物理孔隙度
- 原子间距较远的材料(记住
- 尽量减少电介质中的水分含量,或者设计一种亲水性最低的电介质。由于 k 约为 80,低 k 电介质只需吸收极少量的水即可失去其介电常数优势。
4.5.8. 低 k 材料面临的挑战
- 热机械强度弱:在几乎所有热机械性能方面,都比 SiO2 差 10 倍。
- 层间附着力差
- Cu 附着力差
- MT 蚀刻选择性差
- 热稳定性差
- 拉伸应力
- Va 蚀刻选择性差
- 模量硬度低
- 内聚强度差
4.5.9. 降低介电常数的方法✨
- 降低极化强度和密度。
- 降低 Si-O 密度:SiO2 (k=4)
- 引入 F:SiOF (k =3.7)
- 引入 CH3-:SiOc (H)(k=2.8)
- 使用低极化聚合物:

还可以引入气隙来作为低 k 介质,例如在铜互联或者铝互联中引入。