Q1
a
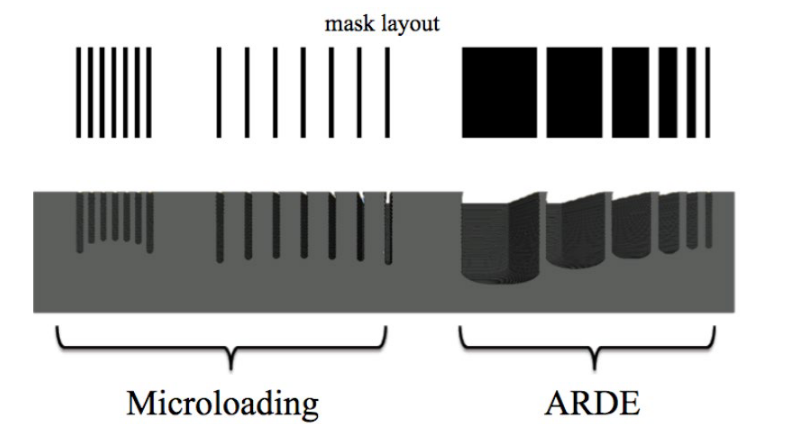
5.3.2.3. 两种离子刻蚀方法总结
指向原始笔记的链接
溅射刻蚀 反应离子刻蚀 成分 方向性 强 可控 选择性 较差 较好 用处 多用于金属 多用于半导体
b
Q2
没讲过的内容,跳了。
Q3
a
浆料中包含颗粒和化学成分,用于软化晶圆表面并通过机械作用对其进行磨损。如果需要对金属薄膜进行抛光,那么需要使用酸性的浆料。酸性浆料能氧化金属表面,例如使得
为了同时得到高去除率和好平面度,最好不要去增加下压力。因为增加下压力的同时可能会导致更多的划痕。
b
主要就是氧化、光刻胶剥离、多晶硅沉积、离子注入等等。
APM 将裸露硅氧化生成原生 (化学) 氧化层,以较低速率 ( ~1Å/ 分钟) 轻微蚀刻氧化层并可蚀刻硅,轻微蚀刻形成底切(减小颗粒与表面的接触), 从而去除表面颗粒。同时可清除有机及金属污染物。
先去除有机物,然后是氧化物,然后是颗粒,最后是金属。
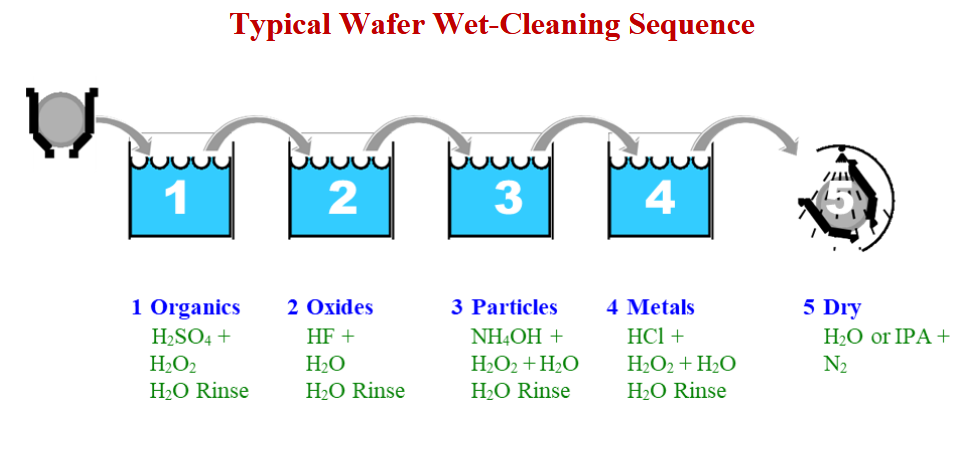
c
注意题目所说的是光学显微镜,
两点最小可分辨距离
指向原始笔记的链接
为自由空间波长; 为浸没介质的折射率; 为透镜在物体处所张半角; 为数值孔径。
约为
AFM 的工作方式是通过探测探针与样品表面之间的相互作用力来实现纳米级分辨率成像。典型的工作模式有接触模式、非接触模式和轻敲模式。为了获得一个低精度的快速扫描,应该使用非接触模式。
Q4
a
其主要用处有:
- 钝化 (保护) 半导体表面的高场区域
- 选择性离子注入的掩蔽
- 非常好的蚀刻选择性
- 作为 MOS 晶体管栅极区域的绝缘层
- 稳定且可重复的 Si/SiO2 界面
- 最终电路保护等
使用干式氧化。干式氧化生成氧化膜的速度慢,密度高,容易精确控制氧化膜的厚度。
通过热氧化生成的二氧化硅为非晶态的 amorphous(CVD 生成的也是)。晶向 100 生成二氧化硅氧化膜的速率最慢。
[! note] 实际上工艺中会经历避免生成晶态的 SiO2,因为晶界的存在会引入漏电路径,且热膨胀系数失配更大,在工艺上也更复杂。
最主要的问题还是隧穿机制导致的漏电,从而使得沟道控制能力的下降,从而使得器件无法完全关闭,静态功耗增加。
b
投影式光刻机最小线宽计算式
指向原始笔记的链接
是一个系统相关的常数,通常为 0.8~1; 是光源波长; 是数值孔径。
数值孔径决定了投影式光刻机的能实现的最小线宽。通过使用更大的透镜或者减小透镜与样品之间的距离就能增加数值孔径。
数值孔径定义公式
指向原始笔记的链接
为数值孔径; 为中间介质的折射常数,空气为 1; 是透镜的光线会聚角,常用透镜的半径除以镜头和硅片的距离 近似。
c
电子波长的计算公式
指向原始笔记的链接
为普朗克常数; 为电子质量; 为元电荷; 为电子束快门和工作台之间的电压差。
渐进式光刻机最小线宽计算式
指向原始笔记的链接
是一个系统相关常数,取 0.8~1; 为光源波长; 为掩膜和晶圆间距。
这里不太确定,应该只能用渐进式的公式,其他的需要 NA 才能算。
Q5
a
负性光刻胶的曝光时间更短。其缺点之一是会导致线宽拓展(溶胀 Swelling)
b
如下图左,

光刻胶对比度定义式
指向原始笔记的链接
为光刻胶开始光化学反应剂量; 为光刻胶光化学反应完全反应剂量。
给出了
如果对比度更低,斜率会更低。
CMTF 定义式
指向原始笔记的链接
为光刻胶开始光化学反应剂量; 为光刻胶光化学反应完全反应剂量。
如果沿用数据,CMTF = 0.8。如果需要成功转移图样,需要 MTF> CMTF,这里条件不满足,所以无法分辨印刷图案。
c
相移掩膜 Phase Shift Mask(PSM):
相移掩膜在掩膜的基础上,通过使用不同材料厚度的图层(相位层)来优化掩膜的临近效应导致的光波扩散。具体来说,相位层通过 180°相位差抵消邻近衍射效应,使得两个区域之间不再形成衍射,提高成像对比度。最直接的效果就是减小了系统常数
光学邻近校正 Optical Proximity Correction (OPC): OPC 就是通过仿真等方法来修正掩膜,例如改变掩膜的边缘以减少衍射的情况,使得光刻后的结果接近图样。