Q
a
平行板 RIE 系统等离子势能计算式
指向原始笔记的链接
为通电电极(阴极)和等离子体之间的电位差; 为接地电极(阳极)和等离子体之间的电位差; 为阳极和阴极的面积比。
可以进一步减小阴极的面积或者增大阳极的面积。如果减小阴极的面积,可能导致产量的下降。可以考虑多个阴极同时进行 RIE 。
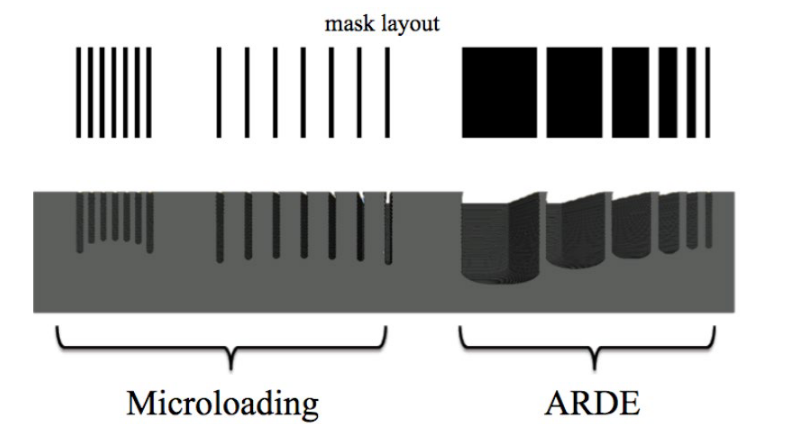
b
先进 CMOS 跳了。
Q2
a
Cu Al Al Cu
用镶嵌工艺(Damascene)刻蚀介质层并电镀铜(Cu)。在铜线之间填充牺牲层介质(如可分解聚合物或SiCOH)。通过干法刻蚀(如O₂等离子体)或湿法刻蚀选择性地去除牺牲层介质,形成空腔。沉积致密的密封层(如SiN、SiC)覆盖气隙顶部,防止后续工艺中杂质或金属渗透。
package 跳
b
下压力:增加下压力可以增加去除率,但是也会导致抛光垫变形从而使得平整度下降;
转速:压板速度的增加线性地提高了去除率;压板速度的增加提高了平面度;在较高的速度下,抛光垫主要接触 “丘陵 ”区域,因为它没有足够的时间来适应 “山谷 ”区域 抛光垫硬度:较硬的抛光垫在压力下变形较小,有较低的 SHR、更高的 PD 和改进的芯片内不均匀性。
较硬的焊盘也会导致更高的去除率和更高的缺陷密度。
k 就是系统参数;P 就是下压力;v 就是转速。
Q3
a
有水蒸气的情况下,氧化速率会更快。一方面水分子更小更容易传过氧化层与基底接触进行反应,另一方面羟基(
b
wet: 0.329
c
我选择用椭偏仪 ellipsometer。精度高至 1nm,且对样品无损伤,操作简单。
d
是 amorphous,晶向(111)。
e
20nm 的薄氧化层适合用干式氧化。因为干式氧化更慢,能精确生成需要的厚度。
f
g
在氧气和
h
通过减小栅极厚度去维持漏极电流和栅极电容的稳定。如果继续减薄会导致隧穿现象,造成漏电,MOS 管无法正常关闭。
Q4
a
Y N N N Y Y Y Y Y N
b
projection printer X 是 Focusing lens

3 0.36
MTF>CMTF ,可以。
c
additive?
Q5
a
投影式光刻机最小线宽计算式
指向原始笔记的链接
是一个系统相关的常数,通常为 0.8~1; 是光源波长; 是数值孔径。
375.42 184.49
DOF 公式
式中,
指向原始笔记的链接是一个与具体的曝光系统及光刻胶工艺特性有关的常数; 是光波长; 是数值孔径。
682.58 271.31
肯定不行
b
相移掩膜、光学临近校正、轴向照明
c
因为水比空气有更高的折射率,相当于增加了 NA 从而减小了线宽。